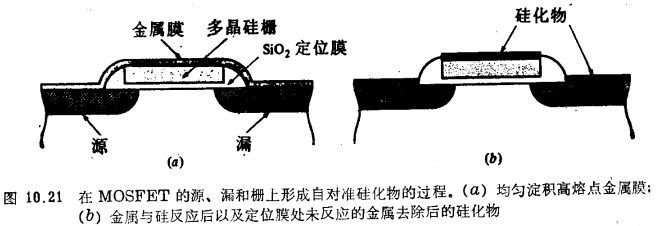
MOSFET漏区-小型化(按比例缩小)的漏区原理及结构MOSFET漏区从前节讨论的NMOS制造工艺流程中可以看到,典型的MOSFET是一对称的器件,即源和漏是等同的,而且沿器件长度方向沟道是均匀的。原则上,源和漏的结构及沟道中的掺杂对于非对称工作来说可以优化,电路中除“传递”晶体管以外大部分器件都以非对称方式工作。MOSFET漏区。但是,目前,与这种优化相联系的工艺上的困难,从期望获得的好处来看还
MOSFET漏区-小型化(按比例缩小)的漏区原理及结构MOSFET漏区从前节讨论的NMOS制造工艺流程中可以看到,典型的MOSFET是一对称的器件,即源和漏是等同的,而且沿器件长度方向沟道是均匀的。原则上,源和漏的结构及沟道中的掺杂对于非对称工作来说可以优化,电路中除“传递”晶体管以外大部分器件都以非对称方式工作。MOSFET漏区。但是,目前,与这种优化相联系的工艺上的困难,从期望获得的好处来看还
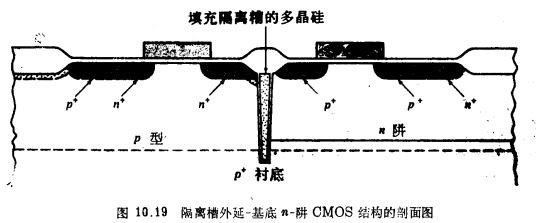
MOSFET源区-小型化(按比例缩小)的源区原理及结构由于不断地改进集成电路的制造工艺,有可能通过不断减小器件尺寸来增加电路的密度和提高电路的速度。5.8节介绍了小型化对器件特性影响的结果并讨论了按比例缩小的方法学。MOSFET源区。本节将要考虑在探求使器件不断小型化时所遇到的制造上的问题和困难。然而,重要的是要看到还有一些这里没有考虑的但与整个电路小型化有更普遍联系的其它一些问题也是很值得注意的
MOSFET源区-小型化(按比例缩小)的源区原理及结构由于不断地改进集成电路的制造工艺,有可能通过不断减小器件尺寸来增加电路的密度和提高电路的速度。5.8节介绍了小型化对器件特性影响的结果并讨论了按比例缩小的方法学。MOSFET源区。本节将要考虑在探求使器件不断小型化时所遇到的制造上的问题和困难。然而,重要的是要看到还有一些这里没有考虑的但与整个电路小型化有更普遍联系的其它一些问题也是很值得注意的
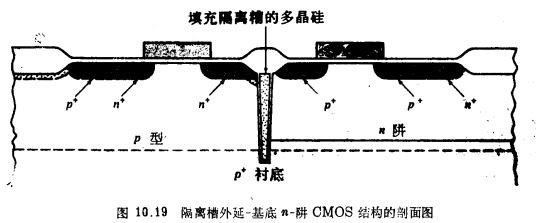
CMOS工艺基本特征及结构的剖面图分析CMOS工艺与NMOS(或PMOS)工艺不同之处是要在同一个衬底上同时制造出n-沟中和P-沟晶体管。在上节描述的NMOS工艺中看到,衬底的掺杂类型和掺杂水平是按照在它上面要制造的n-沟器件的要求来选择的。很明显,在CMOS工艺中,原材料或者是满足n-沟器件的要求,或者是满足P-沟器件的要求,但不能同时满足两者的要求。为了适应不能在原材料上制造的那种类型器件的需
CMOS工艺基本特征及结构的剖面图分析CMOS工艺与NMOS(或PMOS)工艺不同之处是要在同一个衬底上同时制造出n-沟中和P-沟晶体管。在上节描述的NMOS工艺中看到,衬底的掺杂类型和掺杂水平是按照在它上面要制造的n-沟器件的要求来选择的。很明显,在CMOS工艺中,原材料或者是满足n-沟器件的要求,或者是满足P-沟器件的要求,但不能同时满足两者的要求。为了适应不能在原材料上制造的那种类型器件的需
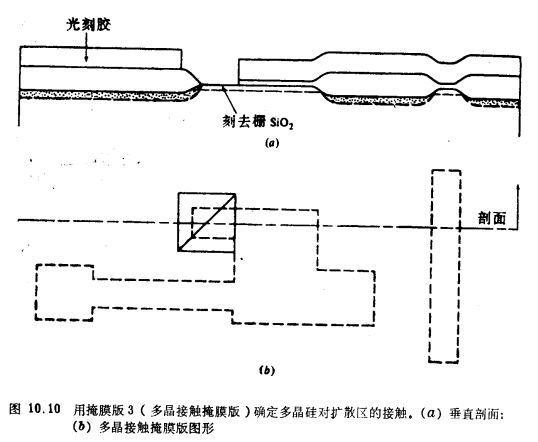
分析MOS晶体管增强/耗尽型NMOS工艺流程实例首先一般地叙述一个硅栅NMOS工艺的典型工艺流程以介绍基本制造工艺的主要特点。这一工艺能同时形成增强型和耗尽型(E/D)MOSFETs。这是一种复杂的工艺,其中包括许多道期待着要进行的工序,因此,有时可能并不清楚为什么要做某件事。MOS晶体管增强/耗尽型NMOS工艺流程。如果渎者有耐心,在读到工艺流程的末尾时,他或她可把整个工艺流程图合在一起,于是每
分析MOS晶体管增强/耗尽型NMOS工艺流程实例首先一般地叙述一个硅栅NMOS工艺的典型工艺流程以介绍基本制造工艺的主要特点。这一工艺能同时形成增强型和耗尽型(E/D)MOSFETs。这是一种复杂的工艺,其中包括许多道期待着要进行的工序,因此,有时可能并不清楚为什么要做某件事。MOS晶体管增强/耗尽型NMOS工艺流程。如果渎者有耐心,在读到工艺流程的末尾时,他或她可把整个工艺流程图合在一起,于是每
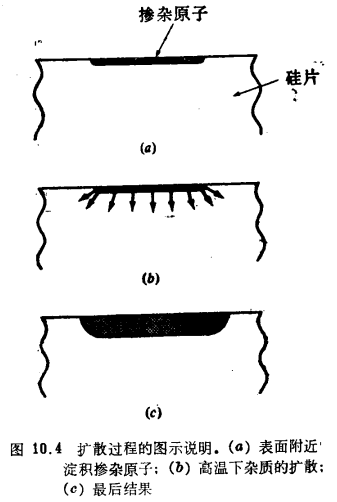
MOS晶体管制造工艺外延的工作原理解析外延与上述所有制造工序不同,外延工艺只在工艺流程开始时使用一次。外延是在硅片顶层生长一层硅薄膜,将硅片置于含有硅的化合物例如SiH4的环境小,在1000到1200℃高温就可发生这一过程。MOS晶体管制造工艺外延。硅化合物的分子在热硅片表面上分解,这些自由化了的硅原子便按照底层晶格的形式排列在硅片表面上。这样,外延淀积的硅薄膜,在晶格排列上与底下的晶体完全重复。
MOS晶体管制造工艺外延的工作原理解析外延与上述所有制造工序不同,外延工艺只在工艺流程开始时使用一次。外延是在硅片顶层生长一层硅薄膜,将硅片置于含有硅的化合物例如SiH4的环境小,在1000到1200℃高温就可发生这一过程。MOS晶体管制造工艺外延。硅化合物的分子在热硅片表面上分解,这些自由化了的硅原子便按照底层晶格的形式排列在硅片表面上。这样,外延淀积的硅薄膜,在晶格排列上与底下的晶体完全重复。
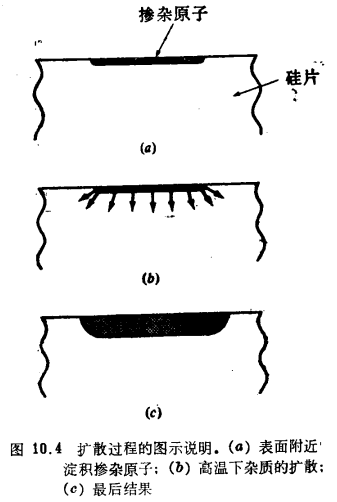
MOS晶体管制造工艺的扩散工序工作原理解析扩散用离子注入法淀积在硅表面附近的杂质原子,用称之为扩散的工艺被驱入硅内较深的位置。MOS晶体管制造工艺的扩散。把硅片置于高温炉内一定时间后(如1000℃,30分钟)就完成了这个过程,这一过程示于图10.4。制造工艺流程进行时,有意或无意的就进行了杂质扩散,例如,当要形成深的掺杂层时,可把硅片置于高温下相当一段时间,有意识地使掺杂原子扩散相当长的距离。MO
MOS晶体管制造工艺的扩散工序工作原理解析扩散用离子注入法淀积在硅表面附近的杂质原子,用称之为扩散的工艺被驱入硅内较深的位置。MOS晶体管制造工艺的扩散。把硅片置于高温炉内一定时间后(如1000℃,30分钟)就完成了这个过程,这一过程示于图10.4。制造工艺流程进行时,有意或无意的就进行了杂质扩散,例如,当要形成深的掺杂层时,可把硅片置于高温下相当一段时间,有意识地使掺杂原子扩散相当长的距离。MO
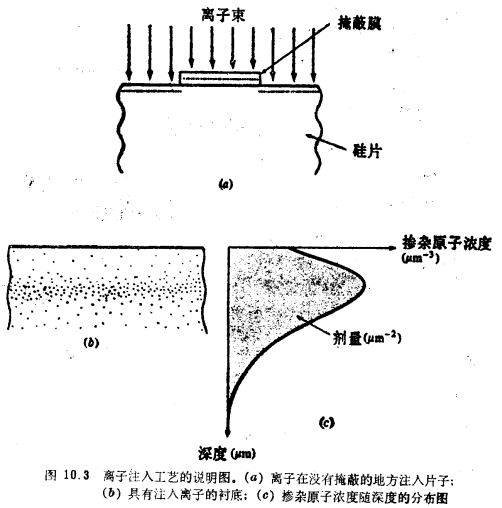
MOS晶体管制造工艺的离子注入的工作原理解析离子注入离子注入是改变掺杂浓度的主要工艺。这个工艺是用离子注入机向整个“靶”片均匀注入精确数量的欲掺入的杂质离子,例如砷(As)、磷(P)、和硼(B)。这些离子首先在静电场中加速,使它们获得足够的能量(10到300keV)进入靶内。MOS晶体管制造工艺的离子注入。这些离子从未用足够厚的“掩蔽膜”来掩蔽的那些需掺杂的地方进入硅靶片内,如图10.3a所示。掩
MOS晶体管制造工艺的离子注入的工作原理解析离子注入离子注入是改变掺杂浓度的主要工艺。这个工艺是用离子注入机向整个“靶”片均匀注入精确数量的欲掺入的杂质离子,例如砷(As)、磷(P)、和硼(B)。这些离子首先在静电场中加速,使它们获得足够的能量(10到300keV)进入靶内。MOS晶体管制造工艺的离子注入。这些离子从未用足够厚的“掩蔽膜”来掩蔽的那些需掺杂的地方进入硅靶片内,如图10.3a所示。掩
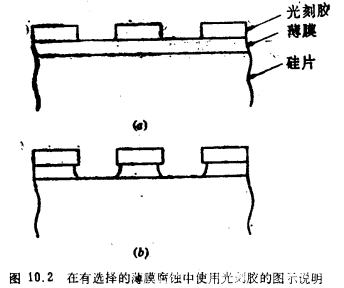
MOS晶体管制造工艺的腐蚀工序的工作原理解析腐蚀腐蚀是把淀积在片子上的薄膜的特定区域去除掉的一道工艺,这一工艺紧接上述光序之后进行。例如,假定通过光刻得到如图10.2a所示的情况。现在把片子暴露在(化学反应的)腐蚀剂中,腐蚀剂把没有光刻胶保护的薄膜区域腐蚀掉,如图10.2b所示。然后用“去胶剂”把光刻胶去除。MOS晶体管制造工艺的腐蚀工序。腐蚀剂的类型决定于待腐蚀的薄膜的类型,例如,待腐蚀的是Si
MOS晶体管制造工艺的腐蚀工序的工作原理解析腐蚀腐蚀是把淀积在片子上的薄膜的特定区域去除掉的一道工艺,这一工艺紧接上述光序之后进行。例如,假定通过光刻得到如图10.2a所示的情况。现在把片子暴露在(化学反应的)腐蚀剂中,腐蚀剂把没有光刻胶保护的薄膜区域腐蚀掉,如图10.2b所示。然后用“去胶剂”把光刻胶去除。MOS晶体管制造工艺的腐蚀工序。腐蚀剂的类型决定于待腐蚀的薄膜的类型,例如,待腐蚀的是Si
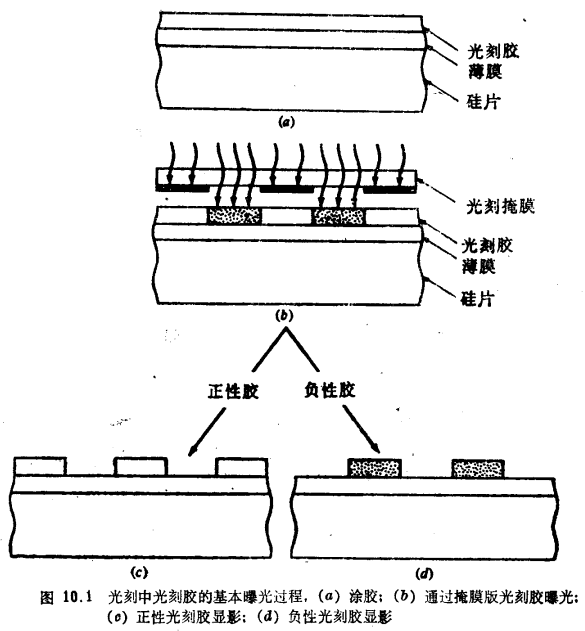
MOS晶体管制造工艺的光刻工序的工作原理解析光刻是这样一种工艺,利用它可将掩膜版上的几何图形转移到片子的表面或转移到覆盖在片子上的薄膜的表面上。要做到这一点,首先在表面上涂一层称为抗蚀刻的聚合物,然后将掩膜版上的几何图形转移到抗蚀剂上。有好多种方法可以完成这种图形转移,但当前最主要的是照相技术,因此,这一工艺称为光刻,这层聚合物称为光刻胶。最初,光刻胶为液态,把它均匀地涂在表面上以后用低温烘焙使其
MOS晶体管制造工艺的光刻工序的工作原理解析光刻是这样一种工艺,利用它可将掩膜版上的几何图形转移到片子的表面或转移到覆盖在片子上的薄膜的表面上。要做到这一点,首先在表面上涂一层称为抗蚀刻的聚合物,然后将掩膜版上的几何图形转移到抗蚀剂上。有好多种方法可以完成这种图形转移,但当前最主要的是照相技术,因此,这一工艺称为光刻,这层聚合物称为光刻胶。最初,光刻胶为液态,把它均匀地涂在表面上以后用低温烘焙使其

MOS晶体管制造工艺的薄膜淀积工序的特征分析制造硅MOS集成电路用的原材料是厚约500μm、直径为7.5到150cm(3到6in)的单晶硅圆片(薄片)。一般,硅片掺杂均匀。典型NMOS工艺,掺p型杂质,电阻率范围是20到60Ω.cm(NA=6*102~2*102μm-3)。对CMOS工艺,掺杂可以是n型的,也可以是p型的,电阻率在5Ω.cm附近(NA=3*103μm-3,或者,ND=103μm-3
MOS晶体管制造工艺的薄膜淀积工序的特征分析制造硅MOS集成电路用的原材料是厚约500μm、直径为7.5到150cm(3到6in)的单晶硅圆片(薄片)。一般,硅片掺杂均匀。典型NMOS工艺,掺p型杂质,电阻率范围是20到60Ω.cm(NA=6*102~2*102μm-3)。对CMOS工艺,掺杂可以是n型的,也可以是p型的,电阻率在5Ω.cm附近(NA=3*103μm-3,或者,ND=103μm-3