电子技术论坛
信息来源: 时间:2022-8-22
MOS晶体管制造工艺的离子注入的工作原理解析
离子注入
离子注入是改变掺杂浓度的主要工艺。这个工艺是用离子注入机向整个“靶”片均匀注入精确数量的欲掺入的杂质离子,例如砷(As)、磷(P)、和硼(B)。这些离子首先在静电场中加速,使它们获得足够的能量(10到300keV)进入靶内。MOS晶体管制造工艺的离子注入。这些离子从未用足够厚的“掩蔽膜”来掩蔽的那些需掺杂的地方进入硅靶片内,如图10.3a所示。掩蔽膜可以是光刻胶、SiO2、Si3N4、多晶硅、或上述材料的组合。靶片内注入离子的典型分布如图10.3b信注入层峰值位置和扩展的程度决定于离子能量、离子质量和靶片的材料,对典型应用来说,它们在0.05μm和0.05μm范围内变化。MOS晶体管制造工艺的离子注入。单位面积注入的离子总数,或“离子剂量”,示于图10.3c,可以精确地控制,一般在102到108离子/μm2之间,决定于使用要求。
在现代IC工艺中,掺杂方法几乎全部使用离子注入,在MOS工艺中主要用于:
1、形成源区和漏区。
2、调节阈值电压。
3、在CMOS工艺中,衬底上需要制作晶体管的区域形成合适的掺杂类型和掺杂水平。
4、减少穿通效应。
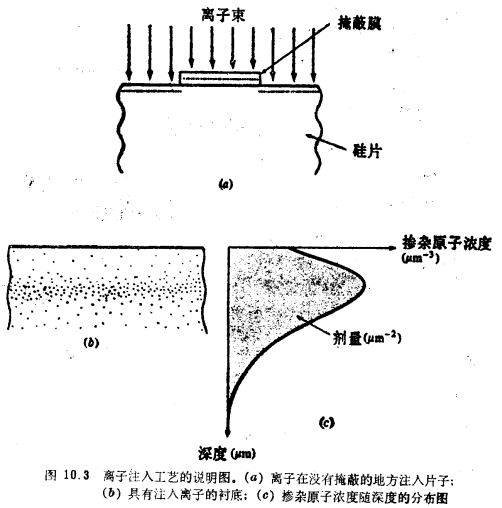
杂质原子可以直接注入硅内,也可以穿过有意形成的薄膜,通常为热生长SiO2,注入硅内。
杂质原子的离子注入经常伴随有硅的晶格损伤,这一损伤是由于每一个注入的离子要与晶格原子发生多次碰撞造成的,直到它停止为止。MOS晶体管制造工艺的离子注入。将硅片放在高温下可使离子注入损伤“退火”(即恢复)并使掺杂原子“激活”(即掺杂原子替位到能被电离的晶格位置上)。这一退火工艺是必不可少的,并且其特点是可与继离子注入后的其他一些热处理结合起来
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




