电子技术论坛
信息来源: 时间:2022-8-3
MOS晶体管通用电荷薄层模型作用及其重要特征
7.4.5节中,我们已经说明怎样用4.3节中的通用模型来计算各种电荷。最后得到的表达式适用于所有反型区。对这些电荷求导可得电容(这不是一件容易的事)。除非对本体电荷采用采用近似式(类似于4.4节中导出近似强反型时所用的近似式)否则最后得到的表达式太长。
为了说明在所有反型区中电容的变化情况,可以固定VDS, 画出电容与VGS的关系曲线。这就是在画图7.9和图8.10时所采用的方法。最后得到的电容曲线示于图8.17中,并在所有区域中都和实验符合得很好。MOS晶体管通用电荷薄层模型。在图8.18中,我们画出了在中反型附近,放大水平标度后的曲线。显然,在这一区域,强反型表达式和弱反型表达式都完全失败了。但是在许多电路CAD所用的模型中,还是认为弱反型表达式和强反型表达式的有效区是紧挨的。

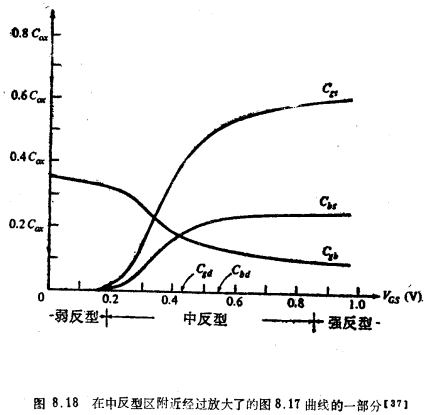
图8.19中,我们比较了gmb/gm,Cbs/Cgs和Cbd/Cgd。可见式(8.3.15)近似地得到了证明。
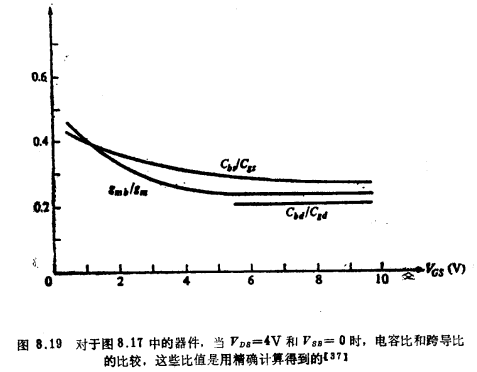
耗尽
在耗尽区,有关的电容只有Cgd。把相应的栅电荷公式(7.4.46)代入定义式(8.3.5)就可得到与弱反型时一样的表达式:

应当注意,上述表达式是通过假设一个具有明显边缘的,完全的耗尽区而推导出来的。然而,若VGB接近VFB(相差小于几个Φt),则就不能明确地定义这样一个耗尽区了,因而上面的表达式将或多或少存在误差。MOS晶体管通用电荷薄层模型。通过考虑氧化层下面载流子的分布(附录F),并结合式(2.6.8)可以进行更精确的计算。
积累
在推导积累区电荷表达式的过程中(7.4.7节), 曾经假设正好位于氧化层之下的大量空穴建立起一导电薄层。运用这一描述或直接把栅电荷公式(7.4.47)代入Cgb的定义式(8.3.5), 可得出

上面关于“导电薄层”的论述只有在深度积累区才真正有效。若VGS只稍微低于VFB,则“薄层”将不会满意地形成,因而式(8.3.40)将不是十分准确的。再有,考虑运动载流子随深度的分布(附录F), 并结合式(2.6.8), 可以精确地计算Cgb。图8.20表示了积累区和耗尽区中的电容Cgb。虚线代表式(8.3.39)和式(8.3.40),实线表示更加真实的特性。
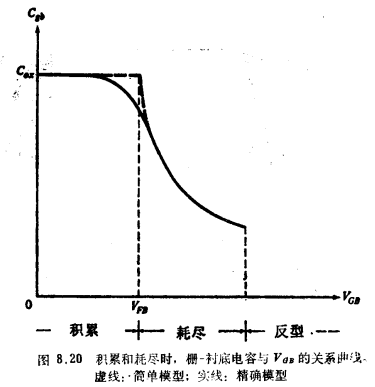
短沟道效应和窄沟道效应
由于存在二维效应,短沟道器件的电容难于计算人们常常依靠测量来解决, 但测量本身也是困难的。由于这样一些器件的电容可能较小,故很容易被由非本征效应,封装和测量线路引起的寄生电容所掩盖。为了使这样一些测量比较容易进行,部分测量装置可和被测晶体管一起集成在同一芯片上。MOS晶体管通用电荷薄层模型。一般情况下,可以观察到电容—电压特性,该特性和沟道长而宽的器件的相应特性定特性相似。但是更困难的工作是:在这些特性曲线上确定出各特定的工作区,因为从这一区到另一区的过渡是十分缓慢的。对于窄沟道器件,电容测量给出了有效沟道宽度 与栅电压的依赖关系(5.4.3节)。
与栅电压的依赖关系(5.4.3节)。
在缺乏完全的解析结果的情况下,短沟道和(或)窄沟道器件的电容可以利用本章所导出的表达式来近似模拟,这时,表达式中的VT和W要用5.4节中所讨论的有效量 和
和 来代替。
来代替。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




