电子技术论坛
信息来源: 时间:2022-7-11
离子注入沟道MOS晶体管的三端结构作用特性
迄今为止,对所讨论的晶体管都假设它们具有均匀掺杂的衬底。对于非离子注入沟道器件而言,这一假设是合理的(虽然严格地说并不正确,因为在氧化层生长过程中杂质会重新分布)。本章将讨论这样一类器件,即通过离子注入有意识地使源漏之间的衬底掺杂很不均匀,所谓离子注入就是在制造过程中用离子轰击衬底。这些离子到达之处,也就是衬底有效浓度改变之地。离子注入也可用于给硅栅掺杂及形成源区和漏区,但是这里我们将集中精力研究它在沟道区中的应明,以剧烈地改变晶体管的I-V特性。离子注入自从早期用于MOS晶体管以来,这一工艺已经得到广泛的应用,现在它已是器件制作过程中的一道标准工序了。人们之所以希望采用离子注入是有若干原因的。其中之一就是调节阈值电压 。就电路设计的目的而论,这个量应该具有已知而简便的值。对于增强型器件,在所有工艺参数的容差范围内;阈值电压都应该足够的正,因而可用等于零的栅-源电压使晶体管截止。从式(4.4.27)可以推断,增加衬底掺杂浓度NA可以获得足够正的阈值电压。但是,这将使ФB和体效应系数γ(2.5节)也都增加了。而γ增大意味着体效应增强,这将使VSB改变时引起较大的VT变化【式(4.4.26)】因此可能使电路设计复杂化。此外,大的NA值会导致大的结电容,而结电容将使电路速度降低。因此,增加NA并非是增加VTo的一种好方法。取而代之的另一种方法是只在十分靠近表面的地方注入离子。这些离子电荷的作用类似于式(2.2.6)中的有效界面电荷Qo的作用,并且它们的效果相当于修正VFB,另一方面,在注入层之下的大部分耗尽区所在地,衬底杂质浓度并未增加。因此,体效应系数和结电容都仍然保持较小的值。可惜注入层太靠近表面,虽然它是调节阈值电压的最佳方法,但是对于处理短沟道器件中所遇到的另一问题却不是最佳的。正如第5章所讨论的,在短沟道器件中,耗尽区的宽度变成占沟道长度的很大一部分,从而导致了包括穿通在内的二维效应(5.6节)。为了防止发生穿通, 耗尽区的宽度应该控制在表面之下,源、漏之间的范围内,这是穿通电流可能流动的地方。从式(1.5.13)明显可以看出,这一要求可以通过离子注入,有选择地增加那里的衬底;掺杂浓度来实现。这样,源区和漏区下面的衬底掺杂仍可保持较低的浓度,因此使结电容仍保持为较小。从以上讨论显然可以看出,设计离子注入器件并非是一件容易的事, 因为它牵涉到若干折衷处理方案。有时使用两重注入,以允许在控制阈值电压和穿通效应两方面保持某种程度的相对独立性。
。就电路设计的目的而论,这个量应该具有已知而简便的值。对于增强型器件,在所有工艺参数的容差范围内;阈值电压都应该足够的正,因而可用等于零的栅-源电压使晶体管截止。从式(4.4.27)可以推断,增加衬底掺杂浓度NA可以获得足够正的阈值电压。但是,这将使ФB和体效应系数γ(2.5节)也都增加了。而γ增大意味着体效应增强,这将使VSB改变时引起较大的VT变化【式(4.4.26)】因此可能使电路设计复杂化。此外,大的NA值会导致大的结电容,而结电容将使电路速度降低。因此,增加NA并非是增加VTo的一种好方法。取而代之的另一种方法是只在十分靠近表面的地方注入离子。这些离子电荷的作用类似于式(2.2.6)中的有效界面电荷Qo的作用,并且它们的效果相当于修正VFB,另一方面,在注入层之下的大部分耗尽区所在地,衬底杂质浓度并未增加。因此,体效应系数和结电容都仍然保持较小的值。可惜注入层太靠近表面,虽然它是调节阈值电压的最佳方法,但是对于处理短沟道器件中所遇到的另一问题却不是最佳的。正如第5章所讨论的,在短沟道器件中,耗尽区的宽度变成占沟道长度的很大一部分,从而导致了包括穿通在内的二维效应(5.6节)。为了防止发生穿通, 耗尽区的宽度应该控制在表面之下,源、漏之间的范围内,这是穿通电流可能流动的地方。从式(1.5.13)明显可以看出,这一要求可以通过离子注入,有选择地增加那里的衬底;掺杂浓度来实现。这样,源区和漏区下面的衬底掺杂仍可保持较低的浓度,因此使结电容仍保持为较小。从以上讨论显然可以看出,设计离子注入器件并非是一件容易的事, 因为它牵涉到若干折衷处理方案。有时使用两重注入,以允许在控制阈值电压和穿通效应两方面保持某种程度的相对独立性。
与上述应用相反,衬底也可用相反类型的离子进行注入(例如,在p型衬底上进行n型离子注入)。这种技术常常用于制作耗尽型器件,这类器件即使当VGB=0时也能导通显著的电流。
具有离子注入衬底的器件的特性现已成为广泛研究的主题。本章的目的是介绍一些有代表性的模型,这些模型在提供易处理的解析结果方面是足够简单的,但是在预测与离子注入衬底有关的大多数重要效应方面又是足够充分的。将要给出的定量结果只限于长沟道器件的漂移电流,这是在文献中已经获得大部分解析结果的情况。
离子注入n沟晶体管示于图6.1;这里的离子注入可以是p型或n型的。和以前一样,我们首先考虑示于图6.1b的较为简单的三端结构。离子注入用“有效剂量”(半导体内单位面积注入的离子数,典型值为103~104/μm2)以及离子离开注入系统时的平均动能(10~300keV)来表示,离子的平均动能决定了它们进入半导体的深度。在半导体内, 离子浓度分布的一般形状如图6.20a的 曲线,其中
曲线,其中 是从Si-SiO2界面开始测量的深度,NAB是非离子注入衬底的掺杂浓度。
是从Si-SiO2界面开始测量的深度,NAB是非离子注入衬底的掺杂浓度。 的形状最初是高斯分布的,然后,随注入工艺之后的高温制造工序而改变。因为
的形状最初是高斯分布的,然后,随注入工艺之后的高温制造工序而改变。因为 的形状复杂,所以详细分析离子注入晶体管是很复杂的。然而,已经发现,用示于图6.2b的曲线去近似
的形状复杂,所以详细分析离子注入晶体管是很复杂的。然而,已经发现,用示于图6.2b的曲线去近似 ,可以获得实际而有用的结果,图6.2b中的NI和
,可以获得实际而有用的结果,图6.2b中的NI和 I是使最终的模型尽可能地精确而选择的适当的常数。作为一种出发点,
I是使最终的模型尽可能地精确而选择的适当的常数。作为一种出发点, I有时选为图6.2a中
I有时选为图6.2a中 =NAB一点的深度,或者选为
=NAB一点的深度,或者选为 等于它的平均值加标准偏差的那一点的深度,此时假设
等于它的平均值加标准偏差的那一点的深度,此时假设 的形状是高斯型的;例如,
的形状是高斯型的;例如, I可能是0.1μm。然后选择NI,使NI
I可能是0.1μm。然后选择NI,使NI I等于总的有效剂量[图6.2a中,
I等于总的有效剂量[图6.2a中, 曲线下的积分]。这里强调一下,上述这些选择仅仅代表了一种出发点。这些参数的最佳值取决于需要模拟I-V特性的哪些方面,以及要求在什么偏压范围内有合理的精度。
曲线下的积分]。这里强调一下,上述这些选择仅仅代表了一种出发点。这些参数的最佳值取决于需要模拟I-V特性的哪些方面,以及要求在什么偏压范围内有合理的精度。
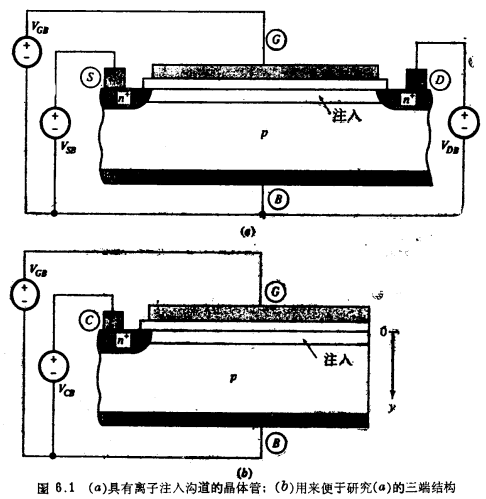
本章将继续采用p型衬底作为例子。注入的离子既可以与衬底杂质同一类型(即受主),也可以是相反类型(施主)。这两种不同注入通常分别用来提高增强型器件的阈值电压和制作耗尽型器件。
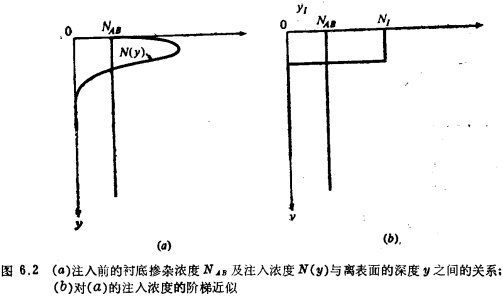
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




