电子技术论坛
信息来源: 时间:2022-6-30
MOS晶体管窄沟道器件作用和特性分析
一个器件沿其沟道宽度方向的截面示于图5-13a。为简单起见,此图画得非常理想化。个实际器件的沟道截面因某些制造工艺看上去可能如图5.13b。一层厚氧化物渐渐地变薄,形成了如图所示的被称为“鸟咀”的特征形状。
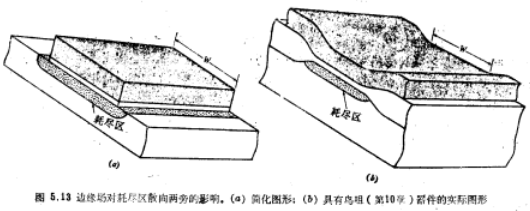
从两幅图中都可看出,耗尽区并不正好限于薄氧化层下面的区域内。这是因为从栅电荷出发的场强线有一些终止在沟道两侧的电离受主上。这些场强线构成了所谓边缘场。如果W较大,则耗尽区的两侧部分占总耗尽区体积的百分数较小,因而可以忽略,然而,当W值只有几个微米时,两侧部分占总体积的百分数就变大了。与短沟道情况相反,现在栅要负责耗尽一个大于第4章的理论所预计的区域(在这一讨论中,假设是长沟道情况)。于是,为了在反型层形成之前,耗尽那样体积的一个区域,VGS必须更大,因而VM、VH和VT必须用较大的“有效量”来代替。另外,当VS保持恒定时,增加VSB会使栅下和两侧部分内的lQBl增加;因而体效应将比宽沟道情况时更为显著。再假设VDS=0,并采用与上一分节中用过的类似的经验方法,于是就可使用有效耗尽区电荷 这个最。这样便可得出有效阈值电压
这个最。这样便可得出有效阈值电压 如下:
如下:

此式与式(5.4.2b)对应,只是这里的 大于1。这样,与式(5.4.1b)给定的既长又宽之沟道的阈值电压VT相比,这里的阈值电压有一增量:
大于1。这样,与式(5.4.1b)给定的既长又宽之沟道的阈值电压VT相比,这里的阈值电压有一增量:

其中

用于对 进行经验估算的方法之一是采用图5.13a所示的简化图形,并假设耗尽区的两侧部分具有四分之一圆的截面。若VDS小到可以忽略,这种方法给出
进行经验估算的方法之一是采用图5.13a所示的简化图形,并假设耗尽区的两侧部分具有四分之一圆的截面。若VDS小到可以忽略,这种方法给出

其中ι是耗尽区的深度,由式(5.4.5)给定,并在正常情况下a3=1。通常,a3已经作为一个引入的经验参数,调整a3可获得最佳一致。比较一下图5.13中的简化图和“实际”图可知,这种经验的调整显然是必要的。把式(5.4.20)和(5.4.5)代入式(5:4.17),可得相应的有效阀值电压 :
:

再把上式和式(5.4.1b)代入(5.4.18),并用 及
及 ,则有
,则有

这一公式与前面的直觉图是一致的。对于1微米数量级的沟道宽度,∆VT1的典型值是零点几伏。∆VT1,这个量并未包括 对VSB的全部依赖关系。必须首先找出在已知VSB值时宽沟道情况下的VT值,然后再加上∆VT1。请注意,在窄沟道器件中,∆VT1表示一个增加量,而在短沟道器件讨论中,∆VT1表示一个减少量。窄沟道和短沟道器件的相反特性表示在图5.14,5.15和5.16中。对于小W(但是大L)的器件,通常假设VT值与VDS无关。[如果按照上面的论述,势必预计VT会随VDS的增加而增加,但是作者知道,还没有关于这种结果的实验证明。]
对VSB的全部依赖关系。必须首先找出在已知VSB值时宽沟道情况下的VT值,然后再加上∆VT1。请注意,在窄沟道器件中,∆VT1表示一个增加量,而在短沟道器件讨论中,∆VT1表示一个减少量。窄沟道和短沟道器件的相反特性表示在图5.14,5.15和5.16中。对于小W(但是大L)的器件,通常假设VT值与VDS无关。[如果按照上面的论述,势必预计VT会随VDS的增加而增加,但是作者知道,还没有关于这种结果的实验证明。]
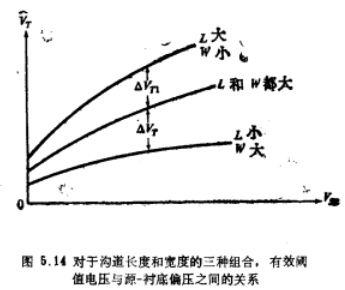
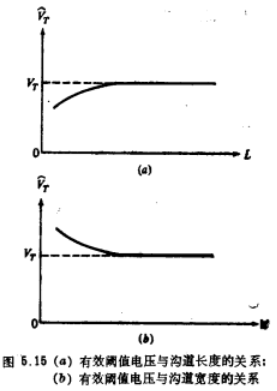
若W不太小,则上述分析方法可能给出满意的结果,这要视具体制造工艺而定。但是,对于某些器件可观察到,若要与实验结果一致,像上面那样只用有效阈值电压 去代替VT是不够的,另外还必须用“有效沟 小W道宽度”
去代替VT是不够的,另外还必须用“有效沟 小W道宽度” 去代替W。遗憾的是,为了估算,还必须或者采用测量方法,或者求助于二维模拟,且这种二维模拟还必须包括所谓“沟道-阻断”区的细节。可以定性地观察到两种效应:(1)随栅压的增加,
去代替W。遗憾的是,为了估算,还必须或者采用测量方法,或者求助于二维模拟,且这种二维模拟还必须包括所谓“沟道-阻断”区的细节。可以定性地观察到两种效应:(1)随栅压的增加, 趋于增大。因为这时图5.13沟道的反型部分势必变宽。(2)随VSB的增加,
趋于增大。因为这时图5.13沟道的反型部分势必变宽。(2)随VSB的增加, 趋于减小。这是因为正如二维模拟(计及沟道-阻断区域)指出的,耗尽区的底部边界实际上呈圆弧形,因而图5.13b中只有在靠近沟道的中心处半导体内的场强线才是垂直于表面的,在靠近两侧处,场强线向旁边弯曲。在这些情况下,中心两侧的反型层的反型程度比预期的弱,或者反型层实际上同时消失。随着VSB的增加,引起 减小这种效应变得更加严重,对于某些制造工艺来说,这种现象可能十分显著。
趋于减小。这是因为正如二维模拟(计及沟道-阻断区域)指出的,耗尽区的底部边界实际上呈圆弧形,因而图5.13b中只有在靠近沟道的中心处半导体内的场强线才是垂直于表面的,在靠近两侧处,场强线向旁边弯曲。在这些情况下,中心两侧的反型层的反型程度比预期的弱,或者反型层实际上同时消失。随着VSB的增加,引起 减小这种效应变得更加严重,对于某些制造工艺来说,这种现象可能十分显著。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




