电子技术论坛
信息来源: 时间:2022-6-28
MOS晶体管速度饱和效应器件特性及其分型层内分析
迄今为止,我们所考虑的所有非饱和区模型,都是基于式(4.3.2)之前所说明的有关反型层内电场的一种假设。为了回顾那一假设,令 为场强的纵向分量(即平行于电流流动的方向,也称为切向或侧面分量)之值。我们已假定,在反型层的所有点上|
为场强的纵向分量(即平行于电流流动的方向,也称为切向或侧面分量)之值。我们已假定,在反型层的所有点上| |都足够小,以致载流子的速度值|
|都足够小,以致载流子的速度值| |正比于|
|正比于| |。在短沟道器件中,可能违反这一假设,因而已导出的ID-VDS关系将不再成立。本节中我们将说明,在这种情况下如何建立合适的模型。
|。在短沟道器件中,可能违反这一假设,因而已导出的ID-VDS关系将不再成立。本节中我们将说明,在这种情况下如何建立合适的模型。
图5.4表示了| |随|
|随| |的变化特性。和体内导电情况一样(1.3节),反型层内载流子的速度在|
|的变化特性。和体内导电情况一样(1.3节),反型层内载流子的速度在| |值很高时①会趋于饱和。由于l
|值很高时①会趋于饱和。由于l l和|
l和| |之间不成比例而产生的对器件特性的影响常常称为速度饱和效应,尽管此时涉及的|
|之间不成比例而产生的对器件特性的影响常常称为速度饱和效应,尽管此时涉及的| |值可能小于图5.4中出现明显饱和倾向时对应的值。
|值可能小于图5.4中出现明显饱和倾向时对应的值。
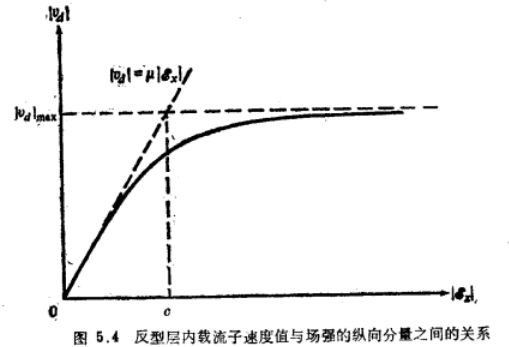
在直线| |=|
|=| |和假想的水平渐近线的交点上(如图5.4中所示),定义一个|
|和假想的水平渐近线的交点上(如图5.4中所示),定义一个| |的“临界”值(记作
|的“临界”值(记作 )是比较方便的。这样,我们有
)是比较方便的。这样,我们有

以及

用于上式的参数值是变化的。当然,| |max和
|max和 的值与以的值应满足式(5.3.2),在室温和垂直场强值(“垂直”是指与电流流动方向垂直)不大的情况下,以的典型值对电子来说约为65μm/(V·ns),对于空穴来说约为23μm/(V·ns)。在有些处理方法中,电子和空穴的|
的值与以的值应满足式(5.3.2),在室温和垂直场强值(“垂直”是指与电流流动方向垂直)不大的情况下,以的典型值对电子来说约为65μm/(V·ns),对于空穴来说约为23μm/(V·ns)。在有些处理方法中,电子和空穴的| |max采用同一值(50到200/μm/ns),该值所对应的
|max采用同一值(50到200/μm/ns),该值所对应的 值,对电子约为0.7~3V/μm,对空穴约为2~10V/μm。在另外一些处理方法中,电子的|
值,对电子约为0.7~3V/μm,对空穴约为2~10V/μm。在另外一些处理方法中,电子的| |max值在上述范围内取,但是对空穴取得略小一些(通常接近相等,有时为1/3),在这种情况下,空穴的
|max值在上述范围内取,但是对空穴取得略小一些(通常接近相等,有时为1/3),在这种情况下,空穴的 值相应地减小了。在取值方面之所以存在这些差异,是因为这些参数难以测量;另外,也因为已经提出了几种不同的理论来解释这些参数。还有,在MOS晶体管的研究工作中,这些理论通常都是被简化地应用的。因此,可用一些经验方法进行数值调整,以改善最后所得器件模型的总体精度。
值相应地减小了。在取值方面之所以存在这些差异,是因为这些参数难以测量;另外,也因为已经提出了几种不同的理论来解释这些参数。还有,在MOS晶体管的研究工作中,这些理论通常都是被简化地应用的。因此,可用一些经验方法进行数值调整,以改善最后所得器件模型的总体精度。
各种经验公式已被用来模拟| |和|
|和| l的依赖关系。这样,在某些处理方法中,图5.4中的曲线用分段直线代替,如已提出用二条渐近线组成的折线来代替。另外一个使用着的关系式是:
l的依赖关系。这样,在某些处理方法中,图5.4中的曲线用分段直线代替,如已提出用二条渐近线组成的折线来代替。另外一个使用着的关系式是:

此式有助于更好地模拟场强在很小和很大之间这一范围内的情况,而且还与式(5.3.1)一致。虽然比式(5.3.3)更为复杂的表达式可以提供更高的精度,但此式还是得到了广泛应用,因为后面将可看到,由它可以得出晶体管的一个简单模型。
现在来考虑在ID-VDS强反型特性的非饱和区的工作情况。和在4.4节中一样,假设全部电流都由漂移引起。令VCB(x)是x点相对于体内的“有效反偏电压”。在一段反型层(比如说长为∆x)两端的电压降等于该段反型层两端的VCB值之差∆VCB。若使上面的有限差值变为微分,则x点的场强值为

这样,根据式(5.3.3),x点的电子速度值就成为

或者利用式(5.3.2),得:

我们不能再利用式(4.4.12)来计算非饱和区的漏端电流IDN。因为那公式是建立在式(1.3.15)基础上的,而式(1.3.15)又是在| |正比于|
|正比于| |的假设下导出来的。由于现在不再是这种情况了,故我们将利用更一般的表达式(1.3.7)。对于MOS晶体管来说,式中的Q’是单位面积的反型层电荷QˊI,它的值取决于VcB(x),并用QˊI[VcB(x)]表示,b是沟道宽度W。因此
|的假设下导出来的。由于现在不再是这种情况了,故我们将利用更一般的表达式(1.3.7)。对于MOS晶体管来说,式中的Q’是单位面积的反型层电荷QˊI,它的值取决于VcB(x),并用QˊI[VcB(x)]表示,b是沟道宽度W。因此

把式(5.3.5b)代入式(5.3.6),可得

从x=0(这里VCB=VSB)到x=L(这里VCB=VDB)取积分,并和在4.4节一样,假定μ与横向场强无关,可得

把VDB-VSB=VDS代入上式,则有

现在把上式与式(4.4.13)进行比较,并假定μ以为常数,可以看出,除了积分号外面的相乘因子 以外,两者是等同的。因此,对迄今所导出的从式(4.4.13)开始的非饱和区漏端电流的各表达式乘以上述因子,都可使它们适用于存在速度饱和效应时的情况。这样
以外,两者是等同的。因此,对迄今所导出的从式(4.4.13)开始的非饱和区漏端电流的各表达式乘以上述因子,都可使它们适用于存在速度饱和效应时的情况。这样

上式的右边可用精确模型(4.4.17),近似模型(4.4.25)或手头现有的任何其他模型,视你所希望达到的精度而定。
例5.2用近似模型(4.4.30a)代入式(5.3.10),我们得到存在速度饱和效应时的电流公式

垂直电场效应(4.8节)也可合并到上述公式中去。若假定迁移率与饱和速度无关,则可把式(5.3.1)和(5.3.2)中的μ用式(4.8.9)来代替,并用4.8节中所提出的近似方法重新推导IDN,于是又可再一次得到式(5.3.11),只是其中的μ用由式(4.8.14)或(4.8.18)给出的有效迁率μeff代替。其他一些方法地可给出类似的结果。
从上面导出的ID表达式不难看出,斜率dID/dIDS达到零时的VDS值小于不存在速度弱饱和效应时所求得的值。这就建议我们作如下简化假设(这一假设的适用性不久就将考虑):第ID-VDS曲线的“饱和”现象将假设纯粹是由速度饱和效应引起的。这样,出现饱和时的VDS值VˊDS可和以前一样用求解dID/dVDS=0的方法求得。
例5.3对例5.2中的模型,建立方程dID/dVDS=0,则有

上式的VˊDS值小于不存在速度饱和效应时所预期的值(VGS-VT)/(1+δ)。该式只在 趋向无限大时(即不存在速度饱和效应时的极限情况),才趋近于(VGS-VT)/(1+δ)。
趋向无限大时(即不存在速度饱和效应时的极限情况),才趋近于(VGS-VT)/(1+δ)。
在饱和区(VDS>VˊDS),计及沟道长度调制效应是必要的。继上面的简化假设之后,我们又假定沟道中邻近漏的区域内(VDS>VˊDS降落在这里)电子密度较低。于是这区域的宽度∆L和5.2节一样,可用式(5.2.1)求得,并再次允许ФD为一经验参数。因此和上面一样,饱和区的漏端电流可从式(5.2.5)和(5.2.6)求得,且公式中的IˊD为VDS=VˊDS时的ID值,而VˊDS可按前面已说过的方法求出。VˊDS的值可用略小一些的 值代替,以使斜率dID/dVDS连续,这一点已结合图5.3c讨论过了。
值代替,以使斜率dID/dVDS连续,这一点已结合图5.3c讨论过了。
在参考文献[36]中,饱和区首先在不作上述简化假设下加以研究,然后以二维计算机模双为指导寻求简化,最后的结果由一些公式组成,这些公式与我们上面得到的表达式具有相同的形式,而且还与实验结果有满意的一致性。
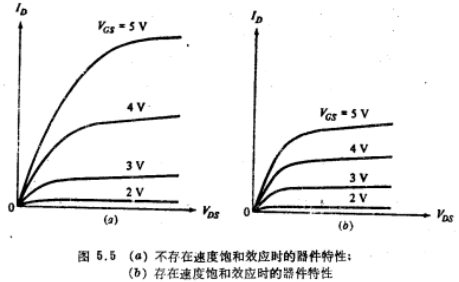
速度饱和效应对ID-VDS特性有严重的影响。图5.5中对一些不存在速度饱和效应(图5.5a)和存在速度饱和效应(图5.5b)时的计算结果进行了比较。可见,对于同样的VGS,当计及速度饱和时,电流达到饱和时的VDS比较小。最重要的是,当计及速度饱和时,饱和曲线的间距不符合式(4.4.30b)的“平方律”。事实上,如果速度饱和效应严重,间距变得近似正比于VGS的增量,如图5.5b所示。这时我们使有一个饱和电流几乎与VGS-VT成线性关系的器件!这一结果可从例5.2和例5.3中的公式看出。速度饱和效应随I.的减小而变得更加强烈。VˊDS随L的减小而减小,虽然不像L本身那样减小得快。忽略沟道长度调制,饱和电流将由式(5.3.11)给出,其中VDS=VˊDS。假定L很小(VˊDS较小),则式(5.3.11)分子中的平方项和分母的第一项1可以忽略,这样

ID与VGS-VT的线性关系是很明显的。这一关系也可表示为另一种形式,由于VDS=VˊDS较小,故可假设沟道电荷近似为均匀分布,即与x无关,因此在任意一点x处,有-QˊI≈CˊOX(VGS-VT)。利用这一事实,并把式(5.3.2)代入式(5.3.13b),便有

如果假设载流子以最大速度运动,则上式可从式(5.3.6)直接得到。
上面两关系式也揭示了在速度严重饱和这种极限情况下的另一主要效应:漏端电流与L无关!有关这一效应的感性知识可从下面的说明中得到。为简单起见,假定载流字都以恒定的最大速度运动,则它们的渡越时间(通过沟道长度所需的时间)正比于。沟道中总的运动电荷也正比于L。因此,等于这一电荷与渡越时间之比的电流就与工无关了。也可以用另一种方法来说明上述结论,假如运动电荷的分布是均匀的,并且电荷以恒定速度运动,则对于给定的W,单位时间内通过的电荷量是固定的,因此漏端电流也是固定的。沟道长度根本不进入这一推理过程,当然,除非工足够小,以致假设速度饱和效应原先就已存在。
上面三段文中所用的近似方法实际上过于筒化,这是因为当沟道长度较小时,源区、漏区附近的二维场对沟道中的电荷有着重要的影响,这将在下节讨论。但是,为了提供直觉知识和把已介绍过的几种结果联系起来,上述讨论还是有用的。注意,因为电子和空穴的| |max相似,故在其他条件都相等时,n沟和p沟器件在速度饱和条件下的工作特性势必相似。在正常工作时,情况并非如此,这是因为ID正比于A,而p沟器件的以值是n沟器件的1/2到1/4。
|max相似,故在其他条件都相等时,n沟和p沟器件在速度饱和条件下的工作特性势必相似。在正常工作时,情况并非如此,这是因为ID正比于A,而p沟器件的以值是n沟器件的1/2到1/4。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




