电子技术论坛
信息来源: 时间:2022-6-15
四端MOS结构通用电荷薄层模型解析
在本节中,我们要推导一个适用于所有工作区的漏端电流表达式。标题中的通用二字就是对这一广泛适用性而言的。电荷薄层这一术语是指这一模型中的基本假设,即反型层具有无限小的厚度①。因为注意到在第2和第3章中已经作了这一假设,所以可把第2、3章中的表达式用到现在的推导中来。下面我们将要介绍的这种模型已在若干参考文献[53,54,56-59]中导出,但是我们的推导方法将更简单。

要使我们将要导出的结果具有通用性,其关键是承认沟道中的电流可由漂移和扩散(1.3节)两种机制引起这一事实。这样,令x为沟道中沿水平方向从源端测量的位置。如果x处的反型层电流记作I(x),则有

为了写出漂移分量的表达式,现在来考虑图4.2a中在反型层内x和x+Δx之间的一个小单元,该小单元被放大示于图4.4中。这一单元两端的电势差的Δψs(x)=ψs(x+Δx)-ψ(x)。把图4.4与图1.5相比较[假设电子速度正比于微小的水平场强,与式(1.3.8)类似],显然可以采用式(1.3.15),但需把V用Δψs来代替,a用Δx,b用W来代替,|Q´|用一|Q´I|来代替,这里的Q´I是x处的(负的)单位面积反型层电荷。μB也必须用一个较小的迁移率值来代替,因为电子平行于表面(半导体-氧化层界面)运动时,会被垂直方向的电场拉向表面,故运动困难。
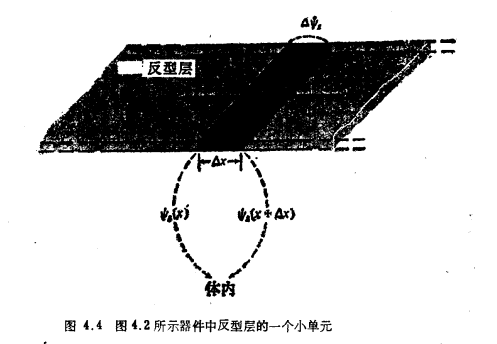
对应的迁移率称为表面迁移率,记为μ(此量将在4.8节中更详细地加以考虑,现在可粗略地假定为μB的一半)。这样便有

令Δx趋近于零,该式便成为

仿照式(1.3.20)可得扩散电流分量:

此处应注意,若假定反型层具有有限厚度,且其中的电子浓度随深度而变,则只要假设电子电流是“层流”,式(4.3.3)和(4.3.4)将仍然适用。这是由于式(1.3.15)和(1.3.20)具有普遍性,这种普遍性已在1.3节相应的脚注中讨论过了。然而,这一点在这里并不十分重要,因为在这里假定所有反型层电荷都集中在离“表面”无限小的深度范围内。
在直流稳态下(本章只讨论这种情况),沟道中的总电流在所有x处都必然相同且等于漏端电流。计及这一事实,并把式(4.3.3)和(4.3.4)代入(4.3.1)可得

把沟道源端处(x=0)的表面势记作ψso,该处的Q´I记为Q´I,表画。把沟道漏端处(x=L)的相应量记为ψsL和Q´I,栅。然后把式(4.3.5)从x=0到x=L积分,可得

由于ID与x无关,故可移到积分符号之外,因此等号左边等于IDL,从而有

这样,我们可把ID看成由两个分量ID1和ID2组成[52,63],

其中ID1由漂移引起

由扩散引起

对ID1和ID2的解释要小心谨慎。注意,由于式(4.3.3)中的I漂移(x)和式(4.3.4)中的I扩散(x)是位置的函数,故一般说来,沟道中的漂移电流和扩散电流可能不是单一值[65]。然而,导出式(4.3.7)的推导过程清楚地表明,之所以有ID1,是因为假定沟道中存在漂移;如果没有漂移,也就没有ID1。同样,之所以有ID2,是因为假定沟道中存在扩散。
现在假定沿沟道μ以为常数(更一般的情况将在4.8节中讨论),于是,μ可移到式(4.3.9)和(4.3.10)中的积分号之外,故得到

为了计算ID1和ID2,我们需知Q´I与ψs的函数关系。前面已经导出过一个合适的表达式,即式(3.2.8a),现重写于下。[当然,假定式(3.2.8a)在这里是适用的,因为在本章开头就作了“缓变沟道近似”。]

根据式(3.2.5b),上式中的Q´B为

因此,Q´I可写成

把上式代入式(4.3.11),便给出由漂移引起的漏端电流分量:

把式(4.3.15)代入式(4.3.12),可给出由扩散引起的漏端电流分量:

现在只剩下根据图4.2a中的外加电压来计算ψso和ψsL这一步了。把图4.2a与图3.1c相比较,我们注意到,为后者导出的表达式可以用于沟道的源端,只要用VsB去代替VCB即可,同样,用VDB去代替VCB这种表达式也可用于沟道的漏端。因此,对沟道的源端和漏端写出式(3.2.7b),便得[53-59]

这些方程可用迭代法对ψso和ψSL求解。这种求解不难用计算机或具有解方程功能的计算器来完成①。ψSL与VDB(或ψSO与ψSB)的关系曲线示于图4.5。图中所使用的符号已在第3章中定义过。标有数字的一些点与将要进行的讨论有关。
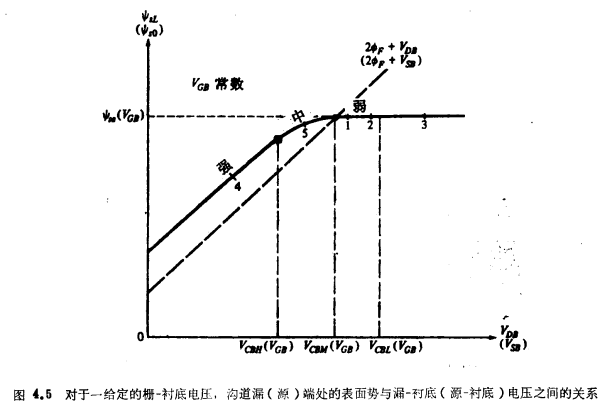
注意,由于忽略了漏附近的边缘效应,结果沟道漏端处的表面势为ψSL,一般情况下,它与n+区的电势是不同的。这样,在n+区的边界上,电势似乎是不连续的。根据3.2节中近末尾处的讨论可以预料,较详细的描述应该计及包含边界的过渡区,在这一过渡区上,电势连续地变化,并最终等于n+区的电势。可以预计,过渡区的长度粗略地等于漏下面耗尽区的深度,在这一过渡区中,不能再假设电场实际上是垂直的。对于沟道源端也可采用类似的论述。基于这样一种描述,在上面的分析中,可以把I解释为除去源、漏过渡区后的沟道长度,而ψSO和ψSL分别表示源端过渡区之右和漏端过渡区之左的表面势。于是,再假设VSB和VDB在两点处的作用基本上相同②,则又可以应用式(4.3.18)了。然而,对于本章中所假设的长沟道,我们可以继续把工看成源漏之间的总距离。注意,为了能获得简单的解析结果,我们采纳了“缓变沟道近似”,而这种近似不能处理上述边缘效应,这样就迫使我们在分析中忽略边缘效应。仔细研究上述效应需要采用二维数值分析。
现在固定VSB,保持VGB为一参数,并变化VDB,于是从式(4.3.18)可求出相应的ψso和中ψsL,并把它们代入式(4.3.16)和(4.3.17)。然后把求得的ID1和ID2按式(4.3.8)那样加起来而求出ID,并绘成图4.3a中的曲线,该图中的电流对应于VDB>VSB,以VGB为参数。这些曲线可以转换成图4.3b中的曲线,该图中的曲线表示了电流与VDS=VDB-VSB的关系,以VGS=VGB-VSB为参数。在两张图上,按表4.1标出了工作区,并用了第3章中所定义的符号表示出了VGB或VGS的界限值。在这里这些值没有多大意义。重要的是单个表达式(4.3.8)能预测所有工作区中的电流,而且还能与实验结果吻合得很好[55-59]。
注意,对于较大的VDB值,所有曲线最终都会饱和。从对应于某一VGB值(比如说VGB4)的漏端电流与漏端处相应的表面势之间的关系,便可理解这一点,现用图4.6来说明。如图所见,增加VDB最终将驱使沟道的漏端进入弱反型,由于第3章中已说明的原因,此时ψSL工实际上变为只取决于VGB=VGB4的常数了。进一步增加VDB再也不能影响ψSL。因而式(4.3.16)和(4.3.17)中的ID1和ID2也变得与VDB无关了。于是可以看出,虽然沟道的源端,比如说,处于强反型,并有很大的|Q´I|,同时ψsO也强烈地依赖于VSB,但是沟道的漏端却处于弱反型,且|Q´I|很小,以及ψsO实际上与VDB无关。不过在沟道的两末端处(以及在整个沟道中)电流是相同的。对于这一结论不应感到惊奇,因为据式(4.3.5)可知,在沟道任意一点上的电流并非只由Q´I确定,这一点将在今后进一步予以讨论。
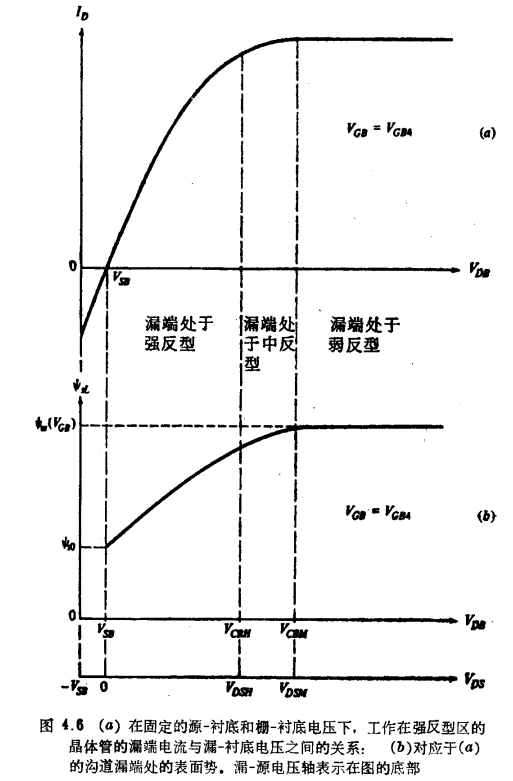
现在来考虑图4.3a中曲线“平坦”部分的一个VDB值。固定这个VDB值,绘出ID及其分量与VGB的关系,则得到图4.7的曲线[53 ]。为了使曲线包括的电流值范围能大些,故纵轴采用对数轴,在横轴上已按表4.1的定义标出了反型区。这里因为VDB大于VsB,因此反型最强的沟道末端是与源相邻的一端。这端处的反型情况可象第3章那样确定。这里我们指出一点,在晶体管文献中,弱反型往往没有下限,也就是说,凡是在中反型之下的都算弱反型,只要电流不小到被漏电电流所掩盖就可以了(见4.6节)。
在图4.7中可见,强反型区内,ID≈ID1,因此电流主要由漂移引起。在弱反型区内,由于ID≈ID2,故电流主要由扩散引起。然而在中反型区内,ID1和ID2两者都重要,也就是说,在这一区内漂移和扩散都起着重要的作用。对于其余的VDB值也有类似的结论。

现在我们来讨论在弱反型区(此时ID~ID2)与式(4.3.17)有关的数值问题。考虑工作在这一区域的一个晶体管,比如说其VSB和VDB分别对应于图4.5中的点1和点2。如图所见,此时ψSL近似等于ψSO(在图中看不出差别)。这样,即使是ψSL和ψSO值的一个很小的误差也会造成差值ψSL-ψSO的一个大的相对误差,而这一差值正是式(4.3.17)所依赖的基本因式。因此在电流中所产生的相对误差也可能较大。于是,只有在特别精确地已知ψSL和ψSO时,才有希望从式(4.3.17)求得ID,求解式(4.3.18)以得到ψSO和ψSL需要经过几次迭代。这说明在弱反型区,式(4.3.17)中的。不能采用近似的显式表达式。在题4.2中提供了克服这一缺点的方法。
从式(4.3.8),(4.3.16)和(4.3.17)清楚可见,ID可写成如下形式:

其中
式(4.3.19)是强调晶体管对称性的一种形式。如果源和漏处的电势互换,则唯一的差别是ID改变正负号。式(4.3.19)形式的ID表达式也可以从式(4.3.7)直接导出。事实上,如果f(ψs)具有一个合适的函数形式,甚至当μ取决于ψs时,式(4.3.19)也适用。
对已经介绍过的通用电荷薄层模型,文献中经常用准费米势(附录I)概念来推导。这将使推导过程较我们的推导更为复杂[53,54,56-59]。不采用电荷薄层近似,而允许反型层向表面以下伸展,甚至允许在耗尽区内还存在空穴,这样进行电流计算也是可能的;包(Pao)和萨(Sah)很早就这样做了[10](附录I)。虽然他们的分析被认为是十分通用和精确的,但由于它包含了重积分的数值计算,因此计算效率低。最近已有人提出重积分公式可以简化为等效的单积分公式[62],但仍要求数值积分。我们所介绍的电荷薄层模型与这些通用公式之间吻合得极好[62],且不要求数值积分。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




