电子技术论坛
信息来源: 时间:2022-6-10
三端MOS结构强反型区及其特性作用解析
三端MOS结构强反型
从图3.2可见,对于给定的VCB值,强反型定义为:

精确计算指出,虽然在深度强反型区内|Q´I|≥|Q´B|,但对于十分接近VGBH的VGB值,Q´I可大于或小于Q´B(Q´I应为|Q´I|,Q´B应为|Q´B|——译者),这取决于衬底的掺杂浓度和氧化层的厚度。决定三端结构在强反型时的真正特性的不是|Q´I|和|Q´B|值的相对大小,而是它们对ψs的斜率的大小;它们对。的斜率正是C´i和C´b。有人发现,在强反型区内,有


如在图3.2a中所见,在强反型区内,ψs随VGB的变化很小,故可假设被“钉扎”在一个略大于ΦH的值上。当VCB=0时,此值与二端结构的相应值一样大,在式(2.5.25)中用ΦB表示。由于这一被钉扎的值接近于,故此值大体上随ΦH与VcB的依赖关系而变。于是,根据式(3.4.3),在强反型区内,这一被钉扎的表面势可用下式来估算:

因而耗尽区宽度也可假设被“钉扎”在ιBm值上,与式(2.5.26)对应,此值可用下式给出:

根据式(3.2.5)和(3.4.17),耗尽区电荷被钉扎在下列值上:


正如3.3节中已说明过的,只对强反型情况而言,VCB可解释为反型层-衬底场感结的有效反向偏压。图3.1c中C和B两端之间的电势差的变化会引起反型层和体内之间电势差ψs的近似相等的变化,只要强反型得以维持。这就是为什么在强反型区内dψs/dVCB≈1的原因。dψs/dVCB≈1可以直接从式(3.4.17)得出,也可以从图3.4中曲线的强反型部分看出。
根据式(3.2.2)至(3.2.4)以及式(3.4.1)可得反型层电荷:

其中

VGBT(VCB)为G-B(栅-衬底)外推阈值电压,其含义已在图3.2d中说明。VGBT通过式(3.4.7)与G-C外推阈值电压①VT(说明见同一图)相联系。因此有

上式可改写为:

式中VT0为VT在VCB=0时的值,用下式给出:

这里的VT0与二端结构的式(2.5.30)中所遇到的VT0当然是同一个量。
VT与VCB的关系曲线已包括在图3.5中。对于各种不同的γ值,由体效应引起的阈值电压增量VT-VT0与VCB的关系曲线示于图3.6①。

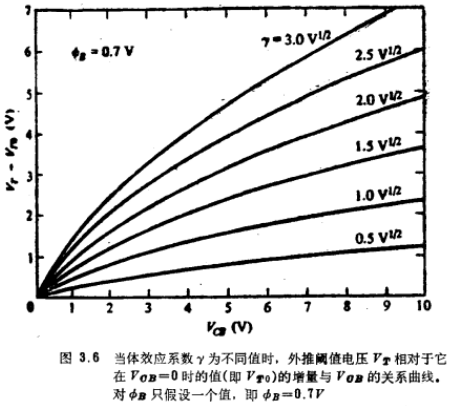
把VGB=VGC+VCB和VGBT=VT+VCB代入式(3.4.20b),可得:

此式对应于图3.2d中曲线的直线部分。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




