电子技术论坛
信息来源: 时间:2022-3-11
MOS管 VLSI随机存储器设计方案及其剖面图解析
随机存储器(RAM)是VLSI的代表产品,是用量最多的VLSI品种。随着工艺水平的飞速进步,RAM的集成度提高很快,在70年代初期单片容量为1K位,80年代中期已达到4M位。
RAM是规则结构,每个存储单元都是完全重复一致的,便于设计。因此,在开发VLSI工艺时一般用它作为先导产品。由于软件技术和人工智能发展的需要,对价廉、大容量的RAM的要求更为迫切,从而促进RAM产品水平的不断提高。
RAM分成为动态和静态两大类,即DRAM和SRAM。DRAM单元简单,单片容量大,适用于计算机的主存;SRAM虽然每片容量只有DRAM的1/4左右,但有使用方便、速度快等优点,因此适用于各种容量较小的高速存储体。
DRAM单元
DRAM发展过程中有过好几种单元形式,至今只保留单管单元一种,因为它有结构简单、集成容量高的优点。产品以一位输出占绝大多数,如64K×1,256K×1,1Mb×1等。采用标准的16腿(256K以下)或18腿(1Mb、4Mb)封装,进行大批量生产,因此体积小、成本低。
电路十分简单,只有两个元件,即一个开关MOS管T和一个存储电容Cs,如图3.1所示。这也是最简单的动态D触发器,其存储讯号的主体是电容,MOS管起地址选择作用,选择是通过字线W和位线B实现的。

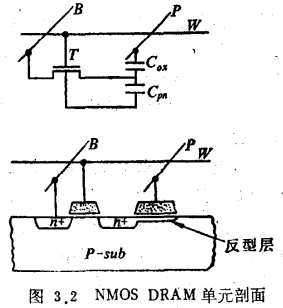
以硅栅NMOS为例,其工艺剖面图如图3.2所示。在此要对存储电容Cs作些说明:它是在多晶硅电极P上加一定电位,在硅电极P下形成反型层,利用该反型层对衬底的pn结电容及对P极平板电容并联,即Cpn和Cox并联,作为存储电容,讯号就存在反型层上。P极的引入加大电容,增加电荷存储量,提高单元的性能。当T管打开时,外讯号可以写入或存储讯号被读出。当T管关闭时存储讯号被动态保存在反型层上,有两种状态:
(1)“0”态自然稳定态,反型层与衬底之间不存在偏压,它们之间为正常的pn结势垒,这种状态能长期稳定保存。
(2)“1”态非稳态,通过T管在反型层上加正压,使pn结处于反偏,耗尽区加宽。当T关闭时这种状态不能长期保持,因为pn结的漏电使存储电压下降,“1”电平逐步衰退为“0”电平。这种状态的保存时间决定于pn结的漏电状况,漏电越少,保存时间越长。目前,按国际通用标准规定,要求保存时间在2ms以上,即规定每隔2ms对各单元刷新一次。这就是应用动态RAM时引入的复杂性。
单元设计的优值标准为:
1、面积小
这是提高集成密度的基础。设λ为工艺设计规则规定的最小尺寸,单元的面积为Nλ2。设计应使N尽量小,即在工艺设计规则允许范围内达到最小面积。
2、电荷传输率T大
T是代表当门管打开时存储电压对位线电压VB的传输比,即

这是电容上电荷再分布的结果。对VLSI DRAM来说,一条位线上有很多单元,CB比较大,因此为了有效地读出单元中电容上的存储讯号,要求Cs尽量大。
3、工艺简单
可以提高成品率和降低成本。相反,工艺越复杂,成本越高。
以上三点要求实际上是互相矛盾的,例如为了加大T,必然要加大面积和增加工艺复杂性,这一点将在本节方案比较中作具体说明。对于VLSI DRAM,最主要的是要求缩小单元面积,提高微细加工技术水平。减小λ是最有效的措施,同时也要注意设计技巧,设法使N尽量小。
单元版图设计的关键因素是B、W、P三条干线的材料及布局,它们必须相互绝缘,字线W和位线B相互垂直,彼此交叉。干线的材料不同,工艺不同,则可以得到如下不同的单元版图设计方案。
1、单层多晶,扩散位线(D-B),金属字线(M-W)方案
这是70年代中期普遍采用的方案,其版图及纵向剖面结构如图3.3所示。它的最大优点是工艺简单,只需要4次光刻。由于单元面积偏大,现在已不采用。

2、双层多晶,扩散位线,金属字线方案
为了缩小面积,对上述单元进行改进,改用双层多晶工艺。它的版图及剖面如图3.4所示,其优点是可以大大缩小面积。这是因为把存储反型层和门管的源区合一,两个单元的门管合用一块多晶硅栅,而且只用了一个接触孔。在相同的设计规则条件下,其N值约为单层多晶的60%。
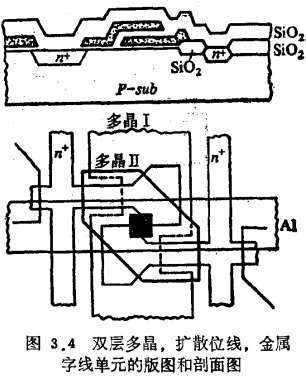
但由此也带来一定的缺点,即门管的栅距与两层多晶的失对中相关,这使短沟管更难精确控制栅距。此外,位线扩散区面积大,CB大,T小。这些缺点有待采用新的方案加以改进。
3、双层多晶,多晶位线(P-B),金属字线方案
为了适应VLSI DRAM的要求,降低CB,改扩散位线为多晶位线,其版图及剖面如图3.5所示。由于扩散区仅限于门管漏区,因而大大减小了CB,但是因为位线电阻比较大而影响读出速度,因此需用金属硅化物代替多晶硅,有效地提高DRAM的性能。
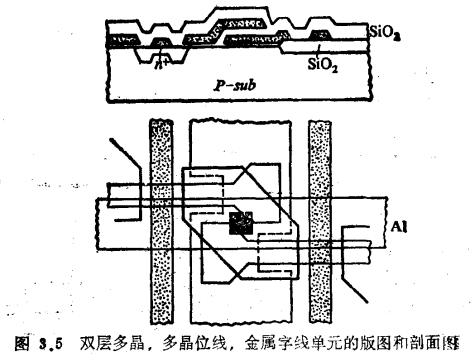
4、双层多晶,金属折叠位线,多晶字线方案
DRAM单管单元的读出讯号较小,因此在位线上必须有灵敏放大器。一般结构都是将单元安排在灵敏放大器的两侧,称为开式结构。把一条位线的各单元分成两段位线,安排在灵敏放大器的同一侧,称为折叠式结构。两者的比较如图3.6所示。

折叠位线结构优于开式位线结构之于抗共轭干扰能力强。从图3.6可以看出,当地址选择改变时,原来两边预充到 的位线中,约有一半电平降到0。通过字线与位线之间的覆盖电容干扰讯号从位线耦合到非选字线,再由字线耦合到被选位线。由于电平变化的位线数量很多(一般达几百条),所以对被选位线产生较大的耦合噪音。采用折叠位线对抑制这项噪音干扰十分有效,因为它们对灵敏放大器的两个输入端的影响是共模式的。其总的干扰效果仅是开式结构的十分之一左右。因此,VLSI DRAM的设计中均采用了折叠位线结构。
的位线中,约有一半电平降到0。通过字线与位线之间的覆盖电容干扰讯号从位线耦合到非选字线,再由字线耦合到被选位线。由于电平变化的位线数量很多(一般达几百条),所以对被选位线产生较大的耦合噪音。采用折叠位线对抑制这项噪音干扰十分有效,因为它们对灵敏放大器的两个输入端的影响是共模式的。其总的干扰效果仅是开式结构的十分之一左右。因此,VLSI DRAM的设计中均采用了折叠位线结构。
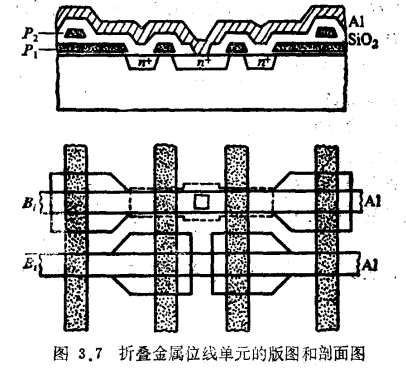
单元的版图及剖面如图3.7所示。由图可见,除了上述抗干扰能力强的优点外,还有位线电阻低、电容小的长处,而且门管栅是由光刻第二层多晶一次完成的,所以沟长的可控性较好。但由于字线用了多晶,字线延迟时间较长,这是本方案的主要缺点。
5、Hi-C双注入单元
为了在不增大面积的条件下增大存储电容Cs,一种方法是减小场板P下绝缘氧化层的厚度,但是它受到氧化硅电击穿强度等限制,厚度不能小于15nm。另一种方法是加大与Cox并联的Cpn,这是一种较为有效的措施。
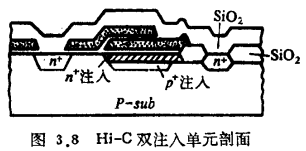
图3.8所示的Hi-C双注入单元的剖面结构可以达到上述目的。选用的工艺过程矿注入万注入是先以受主离子在存储电容区进行深注入,再进行一次施主离子浅注入,以形成一个两边高浓度的pn结,使其pn结电容Cpn大大增加。“Hi-C”单元就是高电容量单元的缩写。
6、C3(Corrugated Capacitor Cell)单元为了进一步减小面积,增大Cs,采用开槽立体电容单元结构,它的剖面如图3.9所示。虽然开槽会使工艺复杂化,但得到了面积小、电容大的好效果,集成容量可以大大增加。
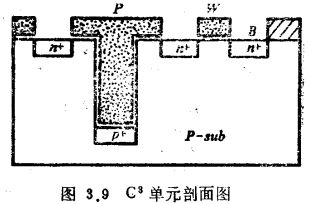
目前,不少Mb级的DRAM单元已经采用这种立体单元结构。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




