电子技术论坛
信息来源: 时间:2022-3-3
MOS管器件DIBL次开启电流区的表面电位分布分析
次开启是指VGS<VTB时源漏之间的漏电,这也是VLSI器件研究的重要课题。一方面随着器件尺寸的缩小次开启问题更严重,会对器件性能带来不利影响,例如动态电路中结点电平不能保持;另一方面次开启区有跨导变化大、功耗低、工作电压低等特点可以有效被利用。
长沟和短沟器件的次开启机理不同。前者起主要作用的是弱反型次开启,它是指表面已反型,但未达到ΦS=2▏ΦP▕强反型时的源漏电流。引起短沟器件次开启的主要原因是DIBL(漏场感应势垒降低)效应,即漏场使源区势垒下降,使电子从源端发射加大,并以扩散形式到达漏端。下面将分别加以分析。
一、DIBL次开启
图1.35为次开启区的表面电位分布。
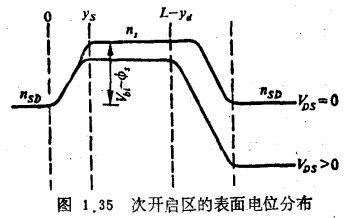
当VDS=0时,沟道区表面电子浓度为:

其中n(Xd)为非表面源耗尽区边界上的电子浓度,
 ,代入上式,得
,代入上式,得

其中nSD为S/D区的电子浓度, 为pn结内建电势。
为pn结内建电势。
如图1.35所示,当VDS加上后,漏区pn结处于反偏,一方面使漏区附近表面电子浓度大大下降,另一方面源区的势垒 有所下降。
有所下降。
漏区边界的表面电子浓度可表示为:

其中yd为漏区表面耗尽区的宽度。
电子沿表面的扩散方程为:

其中Ln为电子的扩散长度。
求解表面电子浓度的分布,由此得到扩散流,即为次开启电流IST,其表达式为:

由边界条件求解(1.130)方程,求得(ns-n)的分布,由此得IST,并考虑某些因素后表示为:

其中K为与短沟MOS结构有关的系数,m是一个拟合系数,使次开启和开启交界处达到电流连续。
为了达到连续,也可以把总电流表示为强反型电流 和次开启电流IST之和,即
和次开启电流IST之和,即

在SPICE MOS4模型中就是采用的(1.133)式。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




