电子技术论坛
信息来源: 时间:2022-2-21
MOS管器件的窄沟道效应特性及剖面图解析
MOS电路中的负载管,经常有W/L<1的情形。对这类负载管如果W设计得太小,就会出现开启升高的窄沟效应,要引起注意。
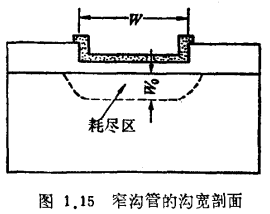
图1.15是窄沟管的沟宽剖面。引起窄沟效应的原因是比较复杂的,在SPICE程序中仅认为是由于在沟宽方向上的边缘场使耗尽电荷增加所致。它的模型如图1.15所示,但要求解耗尽电荷是个多维泊松方程,比较麻烦。
为了便于计算,先把边缘场的影响夸大成四分之一圆形,然后乘以一个拟合系数使影响缩小回来,与实测相符。
令所增加的耗尽电荷量为 ,耗尽层宽度仍是W0,
,耗尽层宽度仍是W0,

则有

其中δ就是由实验决定的拟合系数。
在SPICE中MOS 2和MOS 3对窄沟效应的分析和计算是完全一样的,因此在它们的开启电压公式上都加上与
 成正比的窄沟项,由此得到两者的小尺寸器件VTB的完整公式如下:
成正比的窄沟项,由此得到两者的小尺寸器件VTB的完整公式如下:
MOS 2模型:

MOS 3模型:

式(1.25)中FN即为式(1.24)中的 ,而
,而 则
则 。由以上两式可见,
。由以上两式可见, 越小,窄沟效应越严重。
越小,窄沟效应越严重。
应该指出,上述的窄沟效应的修正方法有原则性的错误,而且与实验结果相差甚远,计算结果比实测结果小得多。这是因为SPICE的窄沟模型没有考虑引起窄沟开启电压升高的更主要的原因。实验证明,引起窄沟效应的主要原因是高剂量的场区截断注入杂质向沟道区侧向扩散所致。

图1.16是采用局部氧化工艺的NMOS管在宽度方向的剖面图。场注P型杂质是为了提高场开启电压,使各MOS管相互隔离。在场氧化过程中,一方面生成“鸟咀”,它是场氧化层与栅氧化层之间的过渡区,另一方面场注P型杂质向沟道内扩散,引起沿沟宽方向的边缘部分的杂质浓度比中心部分高(如图1.16所示),沟宽方向上的边缘部分的开启电压由此而升高。沟道越窄,场注杂质向沟道侧向扩散部分占的比例越大,开启电压上升越多,窄沟效应越严重。但是要导出比较精确的公式来计算这个效应是十分困难的,因为即使能解多维泊松方程,但场注侧向扩散和“鸟咀”形式等重要因素的定量式都是难以确定的。所以至今还没有人真正地定量计算在实际情况下的窄沟效应。
总之,SPICE程序的模型仅仅对大尺寸器件(≥5μm)适用,而对小尺寸离子注入器件的模拟计算会有较大的误差,需要作较大的改进,尤其是对≤3μm尺寸的器件,而小尺寸器件正是VLSI的基本元件。
目前,解决上述问题的比较实际的办法是采用以器件物理原理和实验结果相结合的半经验解析公式。这样的解析式必须尽量简单,以提高计算机的计算效率。
最近发表的1μm级的VTB表达式如下(4):

这个公式与MOS 2、MOS 3公式的不同在于式中各项参量不是常数,而是些变量。
由于考虑了沟道区注入杂质的非均匀分布,表面势Фs 及系数K1,K2,η均是VBS的函数。其函数形式与具体的杂质分布有关,可以用近似分布函数(如三段分布)求解。
短沟和窄沟效应都综合考虑在系数K1中,可以采用比较简单的拟合经验系数形式,可合理地设定

其中LK、WK为实验决定的短沟和窄沟效应拟合系数。
K2和η是与DIBL效应相关联的系数。
在小尺寸情况下,VFB平带电压也随器件尺寸而变化。这是因为沟道内表面势受到源漏区耗尽电场的影响所致。VFB的半经验尺寸修正公式如下:

其中 为大尺寸器件的平带电压,
为大尺寸器件的平带电压, 和
和 为经验修正系数。
为经验修正系数。
对VLSI电路模拟来说,确定比较合理的VTB解析式,并在比基础上得到与实验基本相符的电流公式是计算电路静态特性的首要课题。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




