电子技术论坛
信息来源: 时间:2022-1-14
MOS管器件工作的不稳定性-温度漂移的关系解析
在许多方面,绝缘栅MOSFET相对于温度的稳定性要比其相应的双极晶体管好得多。实际上,这是因为MOS器件是一种多数载流子器件,而通常的p-n结晶体管却为少数载流子器件。因为少数载流子的浓度与本征浓度的平方成正比,而本征浓度又与温度(。K)的立方有很大的关系。(但是,在通常的工作条件下,多数载流子洗度与温度关系悲徽),多数载流子器件在很大的温度范围内,表现出高度的工作稳定性。
如果MOSFET的漏-源电压和栅极电压保持恒定的活,其漏电流就随温度而变化,当然它的变化不如双极晶体管快。这时,引起漏-源电流漂移的机构基本上有两种。
第一,漏-源之间导电沟道中自由载流子的迁移率随温度变化而变化。(这里还是以N-沟道元件为例。)沟道中导带电子的迁移率与散射过程有关,单位时间内电子碰撞的平均次数与迁移率的关系就更为密切。随着温度的增高,单位时圈内电子-晶格碰撞的次数也随之增多。这就导致电子平均漂移速率的降低,固而也就降低其迁移率。综上所述,温度增高,迁移率就减小,从而引起沟道电导率的降低而使漏电流减小。这样,就可以认为迁移率的变化具有一定的负温度系数。迁移率与温度的真实关系已由Gar-tner列表说明,迁移率作为杂置浓度的函数示于图5-4。
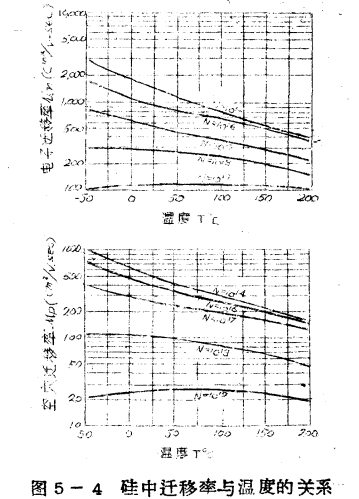
MOS温度漂移的第二种机构是由于S1O2-1界面处存在着表面陷阱状态。与这些状态相应的能级位于导带和价带之间的禁带中。可以假定,其中大多数状态接近于导带而离费密能级相当远因而在进行费密统计时不采用玻耳茨曼近似法。为了进一步简化讨论的过程,假定所有的陷阱都位于一个能级ET上,而(ET-EF)>>KT如图5-5所示。界面处单位体积的陷阱数是NT。
这样,N-沟道器件中表面陷阱俘获的电子数可表示为,

式中ψ为表面的静电势而g为常数。那么

式中γ是激活能。
如果电子解过漏-源之的沟道运动时,被表面陷阱所俘获,电流就要减小。然而,随着温度的增高,陷阱俘获的电子被释放出来的数目也增多,逆且这些电子由于热的激发而升到导带。这就引起了漏电流的增加,这样,温度增高时,由于界面处有一些陷阱电子被激发到导带而使沟道的电导率也增大。从这点意义上来阱,表面陷阱的存在将得到正的温度系数。
幸运的很,温度变化时,两种温度-漂移机构起着相反的作用。因而它倒可以彼此对消从而获得零温度系数的器件。两种机构与温度关系的面数形式是不同的,实际上,人们都是致力于室温附近的温度补偿。利用这种方法,在很宽的温度范圈内都可以得到良好的温度稳定性。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




