电子技术论坛
信息来源: 时间:2021-11-24
MOS电容器在低频时的栅-衬电容及其电压关系分析
对于![]() 这样的频率,反型层电荷随栅极信号的变化,热平衡条件成立。记得制作于p型衬底的MOS器件单位面积总的表面空间电荷密度是由(2.19)式给出,由此可知通过(2.19)和(3.11)式可以得到与表面空间电荷区有关的单位面积电容。MOS电容器低频。简单的微分可以得到
这样的频率,反型层电荷随栅极信号的变化,热平衡条件成立。记得制作于p型衬底的MOS器件单位面积总的表面空间电荷密度是由(2.19)式给出,由此可知通过(2.19)和(3.11)式可以得到与表面空间电荷区有关的单位面积电容。MOS电容器低频。简单的微分可以得到

式中

和

是х=0时半导体表面载流子浓度,而

方程(3.18)可以用 表成
表成

MOS电容器的低频(平衡)电容-电压特性,现在可以利用(2.19),(3.6),(2.10),(2.12),(3.14)和(3.21)式,及下列步骤来计算
1、由(3.20)式中半导体衬底的掺杂浓度决定uF。
2、对于特定值us,从(2.19)可以得到 。
。
3、对于特定值us,现在从(3.6)即可算出VG-VFB。
4、计算(3.21)可以得出单位面积空间电荷电容Cs。
5、对于特定值us,应用(3.14)可以算出单位面积栅-衬电容Cs。
6、在所关注的范围内对许多不同的us值,重复上述程序。
对每一个值算出C,再对VG-VFB作图。以上述方式提出的MOS电容-电压的理论关系是戈茨伯格3(Goetzberger)应用电子计算机作出的。这些曲线的形状随衬底杂质浓度的大小和栅极氧化物厚度的不同而变化。MOS电容器低频。制作于p型衬底、受主杂质浓度范围从1×1014/厘米3到1×1017/厘米3作为二氧化硅栅极绝缘物厚度函数的MOS电容器的典型理论电容-电压曲线表示在图3.8-图3.11中。所得的栅-衬电容值已经归一化成单位面积氧化物电容,并且用归一化电容对栅极电压减平带电压作图。实线表示理论上的低频电容一电压关系。虚线表示栅极电压减平带电压足以使表面反型时,归一化电容的高频特性。(高频特性曲线将在下一节讨论)图3.12到图3.15表示在不同的二氧化硅栅极绝缘物厚度和不同的p型硅衬底受主杂质浓度情况下,表面电势![]() 与栅极电压减平带电压的函数关系。(这些图形的数据是从用来计算栅-衬电容特性的程序的第三步直接得出的。)虽然图3.8到图3.15都是对用P型衬底制作的MOS电容器而言,但是只要改变一下电压坐标轴的符号即可转变为适用于n型硅衬底MOS电容器。
与栅极电压减平带电压的函数关系。(这些图形的数据是从用来计算栅-衬电容特性的程序的第三步直接得出的。)虽然图3.8到图3.15都是对用P型衬底制作的MOS电容器而言,但是只要改变一下电压坐标轴的符号即可转变为适用于n型硅衬底MOS电容器。




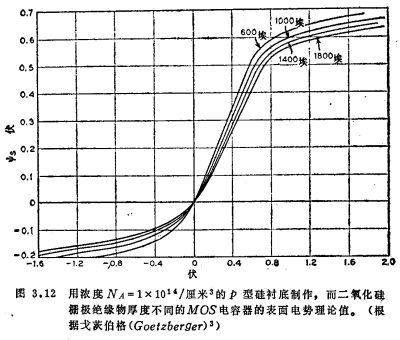


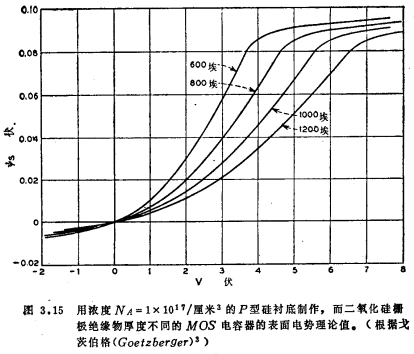
不难看出图3.8到图3.11的理论低频电容-电压曲线与3.1节对它们的特性所作的定性解释是一致的。在积累条件下,单位面积电容近似等于单位面积介电电容Cox。当表面耗尽区形成时,空间电荷电容与介电电容是串联相加的;MOS电容器低频。结果,总的栅-衬电容减小。如果栅极上的外加直流偏压为正值而且足以使硅表面发生反型,此时,反型层电荷将随低频栅极信号发生变化,而表面耗尽区电荷将保持其最大值不变。因此在反型条件下,对于低频栅极信号

结果,在反型条件下,栅极电场任何小信号变化,将由反型层贮存的电荷的涨落来调节,而栅-衬电容将再次上升而趋近于Cox。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




