电子技术论坛
信息来源: 时间:2021-11-18
N沟道MOS管的阈值电压因素及其阈值电压公式详解
固定正值氧化物电荷、绝缘物厚度、衬底电阻率和栅电极功函数对MOS晶体管阈值电压的影响。当对源-衬互连且处于同-电势的MOS场效应晶体管施加栅极电压时,其总电场局限在由栅电极、栅极绝缘物和硅表面空间电荷区所组成的体积内。从高斯定律可知,在平衡条件下,电荷中性条件在此体积内必须成立。从电荷中性条件的要求出发,可以推出p沟道和n沟道MOS场效应晶体管的理论阈值电压。同时也能作出图解关系,以表示MOS阈值电压对于处在二氧化硅内紧靠硅表面一侧的固定正电荷密度、栅极绝缘物厚度、硅衬底电阻率以及栅极材料与硅衬底本身之间功函数差依赖关系。
N沟道MOS管的阈值电压
在平衡条件下,用均匀掺杂的p型硅衬底制作的具有二氧化硅栅极绝缘物的n沟道MOS场效应晶体管的电荷分布由图2.7所示。图2.7(a)表示低栅电压情况,这时在表面层只有耗尽区存在,耗尽区由延伸到x=xd的非可动离化受生构成。图2.7(b)表示栅极电压足够高而使p型衬底表面发生反型,形成一个n型反型层的情况。N沟道MOS管的阈值电压。如前所述,当发生此类情况时,耗尽区将达到最大宽度xdmax。此外,QG定义为栅极单位面积电荷密度,它是外加栅极电压的函数;Qss定义为处于二氧化硅内紧靠氧化物-硅界面一侧的单位面积固定正表面态电荷密度;Qn定义为表面反型层单位面积电荷密度;QSD和QSDmax分别是表面耗尽区单位面积所含电荷密度和最大电荷密度。阈值电压VT则定义为在фs=2фF时达到强反型所需栅极电压。
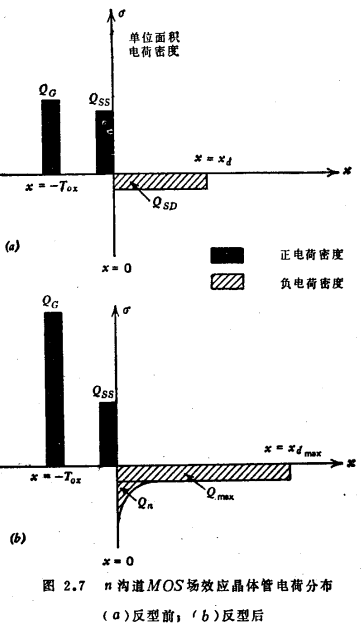
再次假设,当表面电势等于两倍费密电势时,表面空间电荷层的所有电荷都位于耗尽区,并且因正栅极电压的增加而被吸引到硅表面的所有附加负电荷形成反型层的一部分,则当фs=2фF时,Qn=0,电荷中性条件为

在实际的MOS结构中,因为金属-二氧化硅和二氧化硅-硅势垒之间存在差别,以及硅表面的能带弯曲2,氧化层上的电压Vox与外加栅-衬电压VG不同。N沟道MOS管的阈值电压。栅极单位面积电荷密度QG可用MOS结构能带图加以确定,外加栅极电压等于零时的能带图如图2.8所示。金属-二氧化硅势垒记为фMOX,硅-二氧化硅势垒记为фSOX。栅压为零时氧化层的电压记为фOX,0而在零栅压下的表面势记为фS0。。硅的禁带宽度Eg只不过是硅衬底的导带和价带能量之差。如图2.8所示,当外加栅极电压等于零时,在整个结构中,费密能级的位置保持常数。于是存在于二氧化硅栅极绝缘物势垒两侧的能量相加,即有


如量фMS ' 定义为金属-半导体功函数之差,从而

结合(2.38)和(2.39),在VG=0时氧化层总电压即等于

同时可知当栅极有外加电压时,氧化层上的电压降与栅极电压的关系为

因此用氧化层电压、金属-半导体功函数差和表面电势来表示,栅极电压可以表成

迪尔,斯诺,和米德5测量了硅-二氧化硅界面和各种金属电极-二氧化硅界面的势垒高度。他们发现硅-二氧化硅势垒фSOX接近于与硅的晶向和导电类型无关,而等于4.35eV。所测得的金属-二氧化硅势垒高度的结果列于表2.1。这些数据是采用光电发射技术以及MOS电容一电压技术取得的。
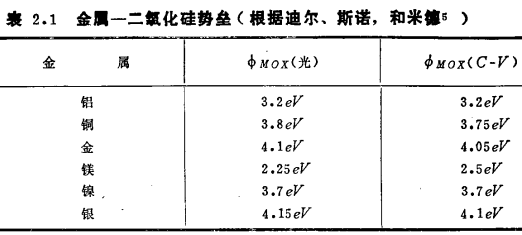
фMS' 是硅衬底导电类型和有效杂质浓度的函数,应用实测的фMOX和фSOX以及费密电势之间的关系式(2.39)即可算出,此处,费密电势是衬底掺杂浓度的函数,可按照衬底导电类型由图2.9或2.10求出。用此方法算出的铝栅电极MOS结构的фMS' 值由图2.11表示。
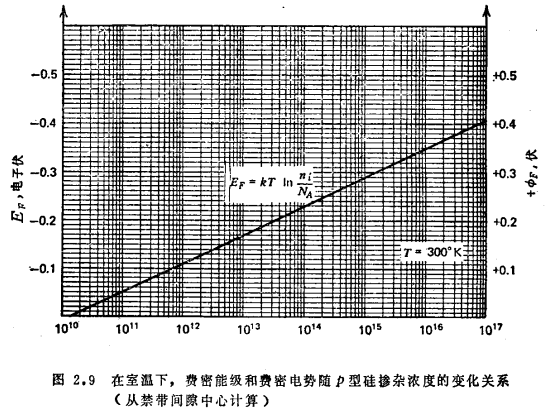
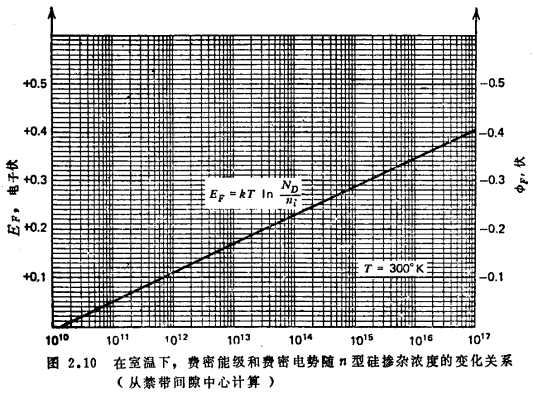

现在栅极单位面积电荷密度可以写为

式中Cox是贯穿绝缘栅氧化物的单位面积的介电电容。根据定义фs=2фF时的栅压为阈值电压VG=VT。结合(2.37),(2.42)和(2.43)得到制作于均匀掺杂衬底上的MOS场效应晶体管阈值电压表示式

方程(2.44)对于n沟道和p沟道MOS场效应晶体管都同样成立。
如前所述,对制作于p型衬底上的n沟道器件,QSDmax为负;相反,对于制作于n型衬底上的p沟道器件则为正值。
应用(2.44)以及由图2.9和2.11得出的фMS'+2фF。N沟道MOS管的阈值电压。值和由图2.6得出的表面耗尽区单位面积最大电荷密度,便可算出在室温条件下工作的铝栅n沟道MOS场效应晶体管阈值电压的理论值,这个值是作为均匀掺杂p型硅衬底的受主掺杂浓度、氧化物-硅界面单位面积固定正电荷密度值以及二氧化硅栅极绝缘物厚度的函数来计算的4。栅极绝缘物二氧化硅厚度为1000A的n沟道铝栅MOS晶体管理论阈值电压的变化,与QSS以及衬底掺杂浓度之间的函数关系,由图2.12中的曲线表示。
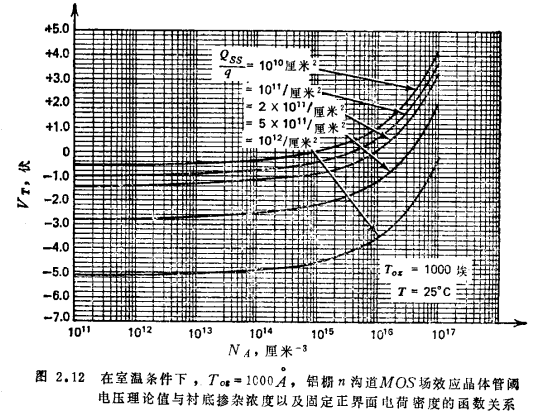
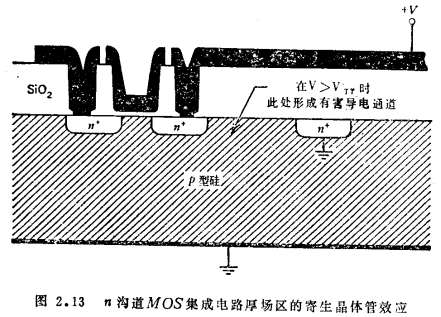
除MOS集成电路的有源开关晶体管的特性之外,与铝接线有关的阈值电压也是十分重要的。因为铝接线是在互不相连的扩散区之上的厚氧化层的上面,厚氧化层可以起到“栅极绝缘物”的作用,如图2.13所示,如铝接线上的电压太高,将会发生表面反型,在互不相连的两个扩散区之间的硅表面将形成有害的电导通道。结果在电路有源区之间发生交叉耦合,很可能导致器件失效,为此集成电路厚氧化层的阈值电压应尽可能地高,俾使有源器件可在较高电压下工作,避免相邻晶体管或扩散区之间形成寄生导电通道。由(2.44)不难看出,只需增加各个晶体管和扩散区之间的二氧化硅厚度,这一点即可作到。不过,从以后各章可以看到,由于存在着一些基本的工艺问题,可以使用的二氧化硅最大厚度是有限制的。MOS集成电路厚氧化层的典型厚度约为15000A。其二氧化硅具有这种厚度的n沟道铝栅厚氧化物结构厚场阀电压VTT作为QSS和衬底掺杂浓度的函数的理论曲线见图2.14。N沟道MOS管的阈值电压。因为在阈值电压和其它同等重要的工艺参数的理论计算中,经常需要联系到与硅衬底的掺杂浓度有关而以欧姆一厘米为单位的电阻率,欧文(Irvin)提出了一个与p型或n型硅的掺杂浓度有关的电阻率的著名实验结果6。为了方便读者,现以图解形式表示在图2.15中。
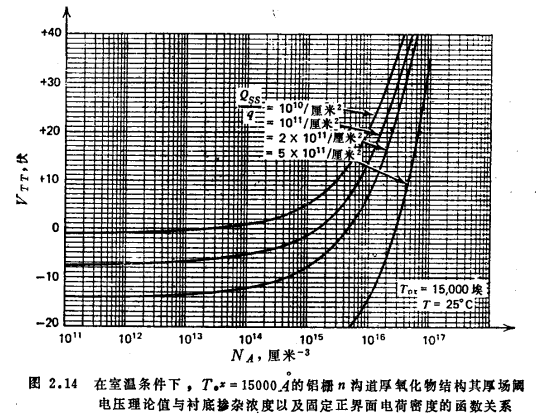

从2.12和图2.14中的曲线可以看出,n沟道MOS场效应晶体管不论是耗尽还是增强型,都是受主掺杂浓度和Qss值的函数。如在氧化物——硅界面上单位面积固定正电荷较大,则n沟道增强型器件制作较为困难,这一事实易从理论曲线看出。对于高电阻率衬底和低Qss值,阈值电压主要由фMS’+2фF项决定,稍稍偏负。对于低Qss值和低电阻率衬底,阈值电压主要由耗尽区单位面积最大电荷密度决定,容易达到阈值电压为正的增强型状态。N沟道MOS管的阈值电压。对于高衬底电阻率,耗尽区内的电荷效应几乎可以忽略。虽然曲线表明,在衬底受主掺杂浓度非常低时,用均匀掺杂硅衬底制作的具有二氧化硅栅极绝缘物的器件发现其阈值电压总是负值,然而应用低浓度扩散技术7,金掺杂8,离子注入9,或多层栅极介质10等工艺措施可以在高电阻率衬底上制成增强型n沟道MOS器件。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




