电子技术论坛
信息来源: 时间:2021-3-3
硅栅CMOS工艺流程框图及等平面隔离硅栅CMOS工艺步骤
1、硅栅CMOS工艺流程框图
虽级然铝栅CMOS工艺比较成熟、稳定,但由于存在着较大的栅漏、栅源交叠寄生电容,使电路速度较慢,再加上n+、p+沟道截止环占用面积较大,集成度做不高等问题,因此,在等平面隔离n沟硅棚工艺的基础上发展了等平面隔离硅栅 CMOS工艺。此种工艺虽然流程较长,但缩小了CMOS电路的面积,改进了电路的速度性能,且版图设计筒单而规则,宜于用计算机辅助制版,因而已成为当前MOS工艺中的主要工艺。
等平面隔离硅棚CMOS的工艺流程框图如图4.1-8所示。

等平面隔离硅栅CMOS工艺流程如图4.1-9所示。
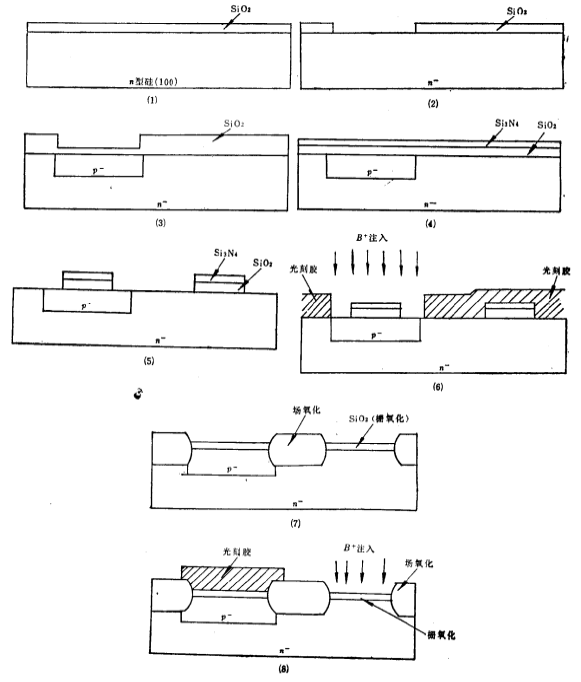
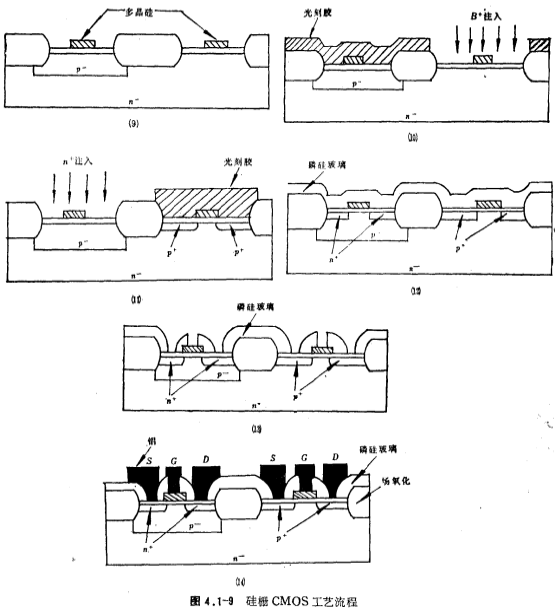
2、工艺流程步骤
结合图4.1-8和图4.1-9,我们简要介绍硅栅CMOS的工艺流程步骤;
(1)预氧化
在n型(100)硅片上进行第一步热氧化,作为P阱注入和再分布的掩蔽。
(2)P阱光刻
(3)P阱硼离子注入和P阱再分布
P阱注入剂量对n沟MOS管的阀值电压 有直接的影响,必须根据电路对
有直接的影响,必须根据电路对 的要求来决定注入剂量,一般为1013/厘米2左右。
的要求来决定注入剂量,一般为1013/厘米2左右。
(4)底氧氧化和Si3N4淀积
首先去掉预氧化层,然后进行底氧化和Si3N4淀积,以作为场氧化的掩蔽。
(5)光刻场区
需要场氧化的地方,通过光刻和等离子腐蚀方法去除该处的Si3N4。
(6)n沟场注入光刻
为提高n沟场区的场开启电压VTF,对n沟场区必须进行硼注入,由于有源区部分已有Si3N4掩蔽,硼离子不会注入进去,因此场注入光刻版与P阱版形状相同,只要把P阱外的区域用光刻胶掩蔽起来即可。硅栅CMOS工艺。n沟场注入的剂量由VTF决定,一般为1013/厘米数量级,注入能量要恰当,能量太低,在场氧化时,容易进入到场氧化层中去;能量太高会穿过Si3N4到有源区,以致影响MOS场效应管的 场注入后进行去胶,去胶后此道光刻图形不再保留。
场注入后进行去胶,去胶后此道光刻图形不再保留。
(7)场氧化及去除Si3N4
通过较长时间的湿氧氧化,在场区生长一层约1微米的氧化层,以提高场开启电压。场氧化完毕后,用热磷酸去除Si3N4。
(8)棚氧化和VTF调整B+注入
去掉Si3N4下的底氧,重新进行清洁氧化,在MOS管栅区上长出一层薄栅氧化感;然后进行 调整光刻。硅栅CMOS工艺。
调整光刻。硅栅CMOS工艺。 调整光刻,只要把n沟MOS管区用光刻胶掩蔽即可,因此可以用P阱的反版,此道光刻不需要腐蚀,去胶后图形不保留。
调整光刻,只要把n沟MOS管区用光刻胶掩蔽即可,因此可以用P阱的反版,此道光刻不需要腐蚀,去胶后图形不保留。
VTF调整用离子注入硼来实现,注入剂量约1011/厘米2数量级,能量可以较低,只要能穿过栅氧化层即可。
(9)多晶硅淀积、多晶硅掺杂和多晶硅光刻
用低压化学气相淀积(LPCVD)方法在整个硅片表面淀积一层多晶硅,然后进行磷扩散,使多晶硅的R□≈30欧姆/方左右,再进行多晶硅光刻,把MOS场效应管栅区上的多晶硅及用作连线用的多晶硅保留,其他地方的多晶硅用等离子刻蚀法去除,
(10)P+区光刻,P+区硼注入
为了进行P+区(P沟漏源区和P阱中的P+环)的硼注入,必须把n+区用光刻胶掩蔽起长,至于场区则有厚的场氧化层掩蔽,MOS管的沟道区有多晶硅掩蔽,可以不必考虑再加作什么掩蔽物。光刻时不必进行腐蚀,即可进行P+区硼离子注入,为减少P沟漏源区的电阻,注人剂量要稍大,一般为1014~1016/厘米2,注入完毕即行去胶,去胶后图形不保留。
(11)n+区光刻,n+区磷(或砷)注入
在进行n+区(n沟漏源区和n-硅衬底中的n+电极)光刻时,必须把P+区用光刻胶掩能起来,为简单起见,只要用P+区光刻的反版即可。硅栅CMOS工艺。光刻后同样进行n+离子注入,随后去胶,图形不保留。
(12)磷硅玻璃淀积和漏源再分布
用低温淀积方法在硅片上淀积一层磷硅玻璃,使高台阶的坡度变小,以利于铝条爬高坡时不致断裂:同时进行漏源再分布。
(13)引线孔光刻
(14)铝淀积、光刻铝条、钝化和钝化版光刻
与其他电路的工艺一样进行铝淀积,铝条光刻和钝化,钝化版光刻。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




