电子技术论坛
信息来源: 时间:2021-3-2
MOS管沟道截止环与局部氧化等平面隔离工艺技术分析
1、MOS沟道截止环
在CMOS集成电路中的场效应管之间,原来应该是自然隔离的,如图4.1-4所示。管1的漏源与衬底反偏置,管2的漏源也与衬底反偏置,因此两只管子漏源之间是相互隔离的。但在实际电路中,管子之间存在着寄生的MOS场效应管,称为场反型MOS管。如图4.1-4所示,两只管子之间的区域称为场区,当场区上跨有带负电的铝条时,只要负电压足够高,场区硅的表面也会反型,而使场反型MOS管导通,场反型MOS管开始导通时铝条上的电压称为场开启电压VTF。要得到管子间良好的隔离特性,要求场开启电压足,够高,至少应大于电路所用的电源电压。

场开启电压的大小与场区氧化层厚度及硅衬底掺杂浓度有关,氧化层越厚,衬底浓度越
高,场开启电压越高。为此,可以用沟道截止环或局部氧化等平面隔离的方法来提高VTF,现管子间的隔离。
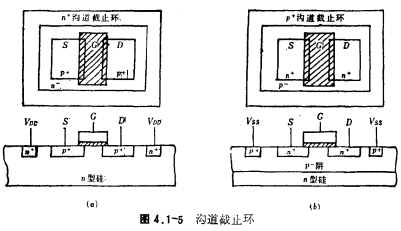
所谓沟道截止环,就是在p沟MOS管的四周衬底上制作一圈n+环,以防止n-衬底区反型成p型而使场反型MOS管导通,如图4.1-5a所示,同时在n沟MOS管的四周衬底(p阱)上制作一圈p+环,以防止p-衬底区反型成n型,而使n沟场反型MOS管导通,如图4.1-5b所示,在CMOS集成电路中,PMOS管的n+沟道截止环可与NMOS管的漏源磷扩散同时进行,NMOS管四周的p+沟道截止环可与PMOS管的漏源翻扩散同时进行,因此,它的制作工艺还是比较简单的;由于截止环是与漏源一起扩散的,故它的浓度较高,所以能得到较高的场开启电压,其缺点是截止环占用面积较大,集成度不高。
沟道戴止环是通过加大衬底杂质浓度来提高场开启电压VTF的,同时还可以采用加大氧化层厚度来提高场开启电压。但若氧化层较厚,会引起场区与有源区之间存在着高的台阶,当铝条跨过台阶时,会产生断铝现象。为了克服这种断铝场象,研制了局部氧化等平面隔离工艺。
2、MOS等平面隔离工艺
局部氧化等平面隔离工艺如图4.1-6所示。它的工艺过程是,在有源区上盖有Si3N4,以掩蔽厚的氧化物的生长,而在场区形成较厚的场氧化层。由于生长SiO2是氧与硅的化学反应,氧化过程中必然消耗掉一定数量的硅,因此约有40%的场氧化层厚度是埋在有源区硅表面以下,这就降低了场区与有源区之间的台阶高度,起到了等平面隔离的效果。其工艺步骤为:(1)初始氧化;(2)淀积Si3N4;(3)光刻场区;(4)场氧化;(5)去除Si3N4。
自从有了离子注入技术后,可以用Si3N4,作掩蔽进行场注入,例如在p沟道MOS管的场区中注入磷,在n沟道MOS管的场区中注入硼,以增加场区衬底的掺杂浓度,进一步提高场开启电压VTF。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




