电子技术论坛
信息来源: 时间:2020-11-30
离子注入法制造MOS源、漏区实现栅自对准
用离子注入法制造MOS器件的源、漏区,可以实现栅自对准。自对准mosfet。但完全由离子注入形成源、漏区的MOS结构是很不理想的。
第一,为了得到P掺杂区较低的薄层电阻,要求注入的离子剂量是很高的(通常大于1013个/cm2),因而会使晶格发生严重的损伤,造成器件很大的反向漏电。如果注入剂量达不到相当的数量,源漏区的方块电阻很大,使器件产生很高的源漏奇生电阻。

第二,由于注入的结深是很浅的,使得源漏耐压很低。
这些原因限制了离子注入法在掺杂方面的使用。自对准mosfet。目前都采用离子注入与扩散相结合的方法,如图6-11所示。
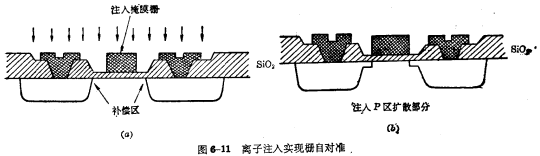
先用扩散技术制作器件的源漏,以得到P区所必须的薄层电阻,然后,用离子注入进行补偿,以形成P区的扩展部分,如图6-11(b)所示。自对准mosfet。采用铝栅是为了保护栅氧化物,同时作为掩膜,使离子注入到预定的区域(称为补偿区),以形成栅自对准结构。
用离子注入法实现栅自对准时,应注意:
①铝栅电极应比普通P沟道工艺尺寸小得多,以留出补偿区进行离子注入;
②为了使硼高子基本上都注入到硅中,在SiO2,中积累尽可能少,离子能量应调节适当;
③硼的注入能量均选在 左右,磷注入能量选用
左右,磷注入能量选用 ,金属层也应有足够厚度;
,金属层也应有足够厚度;
④实际工艺中,补偿区范围可以从几微米到几十微米,氧化层厚度 左右,铝金属层厚度400nm左右,所获得的补偿区薄层电阻为4000Ω/口,退火时间15分,温度为500℃左右。
左右,铝金属层厚度400nm左右,所获得的补偿区薄层电阻为4000Ω/口,退火时间15分,温度为500℃左右。
必须注意,因为注入在铝电极形成之后,故退火温度不能过高,不能超过铝硅共熔点。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助



