电子技术论坛
信息来源: 时间:2020-10-22
MOS器件的阈值电压定义及分析
MOS器件的阈值电压
1、阈值电压VT
所谓MOS器件的阀值电压,是指器件的漏源刚好导通时的栅电压。这实际上要满足Si表面达到强反型条件,即表面势 。MOS阈值电压。那么究竟要加多大的栅电压才能满足强反型条件呢?如果源极接地,这里的栅电压就是指栅源电压VGS。
。MOS阈值电压。那么究竟要加多大的栅电压才能满足强反型条件呢?如果源极接地,这里的栅电压就是指栅源电压VGS。
由前面的分析知道,一个实际的MOS器件要达到强反型,首先要建立平带条件。必须在栅极上加一个电压,以抵消由于功函数差及有效表面电荷对能带的影响,使能带变平。这个平带电压,由(1-18)与(1-20)两式之和给出,即:

在平带的基础上,还必须再在栅上施加一个电压,以达到强反型条件,这个电压(1-1)式给出:

这里,

所以,

 称为本征阀电压,即理想MOS器件的阈值电压。
称为本征阀电压,即理想MOS器件的阈值电压。 为空间电荷区中单位面积的电荷量。MOS阈值电压。对于N型材料,
为空间电荷区中单位面积的电荷量。MOS阈值电压。对于N型材料, 为正值,对于P型材料,
为正值,对于P型材料, 为负值。
为负值。
将(1-21)和(1-22)两式相加,即得到MOS器件的阈值电压的表达式:

(1-23)式是通过分析N沟道MOS系统得来的,但它是一个普遍公式,也适合于P道MOS器件。对于不同的材料,阀值电压式中各个因素取值的正负是不同的,可归纳于表1-2中。

由表可见,对于N型衬底的P沟道MOS器件(1-23)式中四项符号一致( 一般小于零),可以理解为四项取绝对值相加,并在和数之前加负号。因此N型衬底总是做出增强型器件,其阀值电压VT是负的。而对于N沟道MOS器件,由于P型衬底的
一般小于零),可以理解为四项取绝对值相加,并在和数之前加负号。因此N型衬底总是做出增强型器件,其阀值电压VT是负的。而对于N沟道MOS器件,由于P型衬底的 ,所以有可能出现下面的情况,即:
,所以有可能出现下面的情况,即:

在这一情况下,阀值电压为负值,说明沟道已经形成,成为耗尽型器件。在生产N沟道增强型MOS晶体管时,往往容易出现表面耗尽,所以必须采取有效措施,例如衬底的电阻率一定要取得很低(一般至少在 以下),在工艺中尽量降低氧化层中的有效正电荷密度,使上述不等式的不等号换向,即:
以下),在工艺中尽量降低氧化层中的有效正电荷密度,使上述不等式的不等号换向,即:

这样才能得到VT为正值的N沟道增强型器件。
对于增强型器件,阈值电压总是随氧化层厚度增加而增加,对耗尽型器件,实际碰到的情况,也是如此。
下面举例说明有关阀值电压中各项的典型数据。MOS阈值电压。常见P沟道MOS器件的阈值电压为-4V,N型衬底的掺杂浓度约为 氧化层厚度
氧化层厚度 根据上面数据,先查图1-10得
根据上面数据,先查图1-10得 再查图1-18得
再查图1-18得 ,然后算得
,然后算得

从该例子可看到一般P沟道MOS晶体管的阅值电压主要由 三项决定。可见衬底电阻率的选择及工艺上对
三项决定。可见衬底电阻率的选择及工艺上对 的控制是决定阀值电压的重要因素。
的控制是决定阀值电压的重要因素。
2、短沟道效应对VT的影响
上面我们在导出VT的公式时,所考虑MOS晶体管的沟道是),漏、源扩散区耗尽层对VT的影响就不能再被忽略了。一般说来,短沟道MOS晶体管的VT要比与沟道MOS晶体管的VT小。在短沟道的情况,VT不仅与 衬底浓度N及
衬底浓度N及 有关,而且还与沟道长度L和漏、源扩散区的结深
有关,而且还与沟道长度L和漏、源扩散区的结深 有关,图1-15表示MOS晶体管VT与沟道长度L的实验关系曲线。可见,沟道愈短,VT减小的速率愈快。造成这种影响的原因在于沟道耗尽层中电离杂质电荷密度
有关,图1-15表示MOS晶体管VT与沟道长度L的实验关系曲线。可见,沟道愈短,VT减小的速率愈快。造成这种影响的原因在于沟道耗尽层中电离杂质电荷密度 对VT的贡献减小了。MOS阈值电压。在长沟道的情况下,可以认为在沟道L下面的全部
对VT的贡献减小了。MOS阈值电压。在长沟道的情况下,可以认为在沟道L下面的全部 都对VT有贡献,而在短沟道的情况下,由于沟道两端的源、漏扩散区对沟道内静电势分布的影响增强,源漏扩散区中耗尽层电离杂质电荷的电力线,将有一部分终止在沟道下面的耗尽区,如图1-16所示。这样,就削弱了
都对VT有贡献,而在短沟道的情况下,由于沟道两端的源、漏扩散区对沟道内静电势分布的影响增强,源漏扩散区中耗尽层电离杂质电荷的电力线,将有一部分终止在沟道下面的耗尽区,如图1-16所示。这样,就削弱了 对VT的贡献。也可以认为沟道下面耗尽区电离杂质
对VT的贡献。也可以认为沟道下面耗尽区电离杂质 减少了,故使VT减小。
减少了,故使VT减小。
理论计算,短沟道MOS晶体管的阀值电压Vr为:

其中 为源漏扩散区的扩散深度,L为沟道长度,
为源漏扩散区的扩散深度,L为沟道长度, 为耗尽区的宽度。从(1-25)式可见,要减弱短沟道MOS品体管沟道长度对VT的影响,必须减小漏、源扩散区的结深
为耗尽区的宽度。从(1-25)式可见,要减弱短沟道MOS品体管沟道长度对VT的影响,必须减小漏、源扩散区的结深
 ,或增大衬底杂质浓度N。
,或增大衬底杂质浓度N。
3、背面栅数应对VT的影响
MOS晶体管作为单管使用时,它的源和衬底连接在一起,共同接地。但当MOS晶体管构成电路时,有些管子的源和村底不直接相连,例如在
衬底和源极之间加上一定的偏置电压Vas。如图1-17所示。
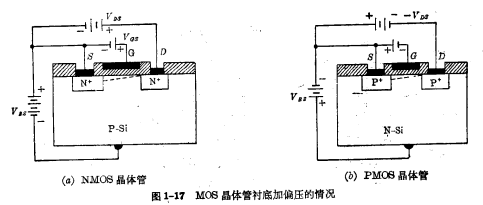
当源极与衬底之间加偏压后,使源扩散区和衬底之间的PN结处于反向偏置。这样,沟道要受到衬底偏置电压的调制。这种效应通常称为“背面栅”效应,或“衬底偏置效应”。
从图1-17中看到,反向偏置电压 是通过源极加在沟道和衬底之间的,因为沟道是很薄的,可看作为单边突变PN结的N+区,反向偏置的结果会使沟道和衬底间的耗尽层向衬底内部展宽,耗尽层中的电荷增多。由于要保持MOS系统的电中型条件,必定会减少沟道中的电子电荷,使沟道变得更薄。MOS阈值电压。如果要维持原来的沟道宽度,就必须在栅极上积累更多的正电荷,以平衡耗尽层中增加的负电荷。这就意味着要增加阀值电压
是通过源极加在沟道和衬底之间的,因为沟道是很薄的,可看作为单边突变PN结的N+区,反向偏置的结果会使沟道和衬底间的耗尽层向衬底内部展宽,耗尽层中的电荷增多。由于要保持MOS系统的电中型条件,必定会减少沟道中的电子电荷,使沟道变得更薄。MOS阈值电压。如果要维持原来的沟道宽度,就必须在栅极上积累更多的正电荷,以平衡耗尽层中增加的负电荷。这就意味着要增加阀值电压
 沟道变薄,甚至消失。这就说明,偏置电压
沟道变薄,甚至消失。这就说明,偏置电压 的绝对值越大,阀值电压的增加量
的绝对值越大,阀值电压的增加量 也越大。图1-18表示沟道随
也越大。图1-18表示沟道随 变化的情况。其中(a)为
变化的情况。其中(a)为 沟道未受到调制;(b)为
沟道未受到调制;(b)为
 的大小,可以从阀值电压的表示式求得。由于源极和衬底加了反向偏置电压以后,能带的弯曲程度愈甚,空间电荷区中的电荷密度增加,其数量由下式给出:
的大小,可以从阀值电压的表示式求得。由于源极和衬底加了反向偏置电压以后,能带的弯曲程度愈甚,空间电荷区中的电荷密度增加,其数量由下式给出:

于是阀值电压的表达式可改为:

将(1-27)式减去(1-23)式,得到:

如果是P沟道MOS管,当衬底与源极之间存在偏压 时,如图1-17(b)的情况,阀值电压的增量为:
时,如图1-17(b)的情况,阀值电压的增量为:

根据以上分析知道:
对于N沟道MOS晶体管,因为
 所以得到
所以得到 对于P沟从(1-28)、(1-29)两式表明,
对于P沟从(1-28)、(1-29)两式表明, 与衬底浓度和偏置电压的大小有密切关系。如图1-19所示。道MOS晶体管,因为
与衬底浓度和偏置电压的大小有密切关系。如图1-19所示。道MOS晶体管,因为 所以得到
所以得到

在工程计算中,为了方便起见,阀值电压的增量往往采用近似表达式:

式中的为衬底偏置效应常数,它随衬底掺杂浓度而变化,其典型值为:对于N沟道MOS晶体管, 对于P沟道MOS晶体管,
对于P沟道MOS晶体管,
 最后,还得对VT着重说明一点,上面所说的MOS器件的阈值电压阀值电压VT,正好是形成沟道时的栅电压,与管子的几何尺寸无关。MOS阈值电压。但在生产实际中,VT往往定为漏源电流为
最后,还得对VT着重说明一点,上面所说的MOS器件的阈值电压阀值电压VT,正好是形成沟道时的栅电压,与管子的几何尺寸无关。MOS阈值电压。但在生产实际中,VT往往定为漏源电流为 时所施加的栅电压,这和上面讲到的不完全一样。因为
时所施加的栅电压,这和上面讲到的不完全一样。因为 时定出的阀值电压往往还在一定程度上依赖几何尺寸,所以生产中测出来的阀电压,要比上面所讲的阀电压大些。
时定出的阀值电压往往还在一定程度上依赖几何尺寸,所以生产中测出来的阀电压,要比上面所讲的阀电压大些。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助



